Enlight® 光學晶圓檢測

隨著半導體設計與晶圓製程的複雜度提高,晶圓廠的成本已隨之攀升。除此之外,成本攀升限制了晶圓製造的檢測頻率。然而,最先進的電晶體線寬尺寸極小,這使得有害良率的缺陷很難從雜訊區分出來;同時,細微偏差也可能積少成多,在製造 3D 結構與執行多重線路的複雜步驟時形成不利於良率的缺陷。所有這些挑戰都指出需進行更頻繁的晶圓檢測。
Enlight 光學檢測系統是應用材料採取創新製程控制的一部份,能讓晶片製造商獲得所期望的極高檢測靈敏度,更頻繁地進行檢驗、 收集更多缺陷資料、加速良率,以及降低每片晶圓的成本。該系統整合了領先業界的速度與高解析度及先進的光學技術,能在每次掃描中獲取更多資料。該系統獨特的結構擁有市面上最高的數值孔徑,可完成高解析度掃描與 3D 極化控制以抑制晶圓雜訊。該系統也是唯一同時具備反射與散射偵測通道,以及彈性影像運算功能的系統。而所有這些功能都能在製造時產生高品質的大數據。
Enlight 系統能藉由所產生的大數據,讓捕獲關鍵缺陷的成本降低 3 倍。而較低的檢測成本讓晶片製造商能增加晶圓檢驗平率與數量,並完成快速、精準的缺陷原因判斷。大數據還能讓晶片製造商進行產線監控,以獲得即時的良率偏差預測與偵測。
在應用材料整體方案中,還運用了應用材料創新的 ExtractAI™ 技術;該技術可搭配 Enlight 系統的大數據,並解決與檢測環節中最棘手的問題:能將不利於良率的缺陷從雜訊中區分出來。運用統計與機器學習的處理演算法,ExtractAI 能以獨特的方式,即時的連結Enlight 系統、應用材料領先市場的電子束 (eBeam) 檢視與SEMVision® 分類架構。這項技術的效率非常高,能以 0.001X 的潛在缺陷率,在每一個缺陷之間逐步引導 SEMVision,並擷取到晶圓上所有有意義的缺陷。ExtractAI 能即時學習、修正,快速地建立起分類完整且完全無雜訊的晶圓缺陷圖,以利後續的晶圓製造。
ExtractAI 技術、SEMVision 電子束複檢功能與應用材料的 Enlight 光學檢測結合後,將能讓晶圓廠以比以往更快的速度提升良率、加速上市時間並降低其擁有成本。

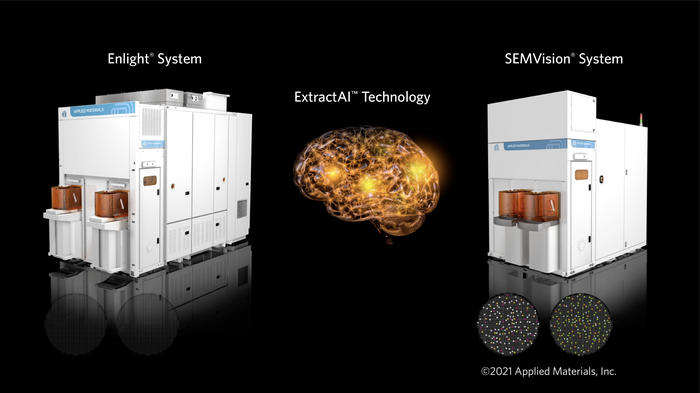
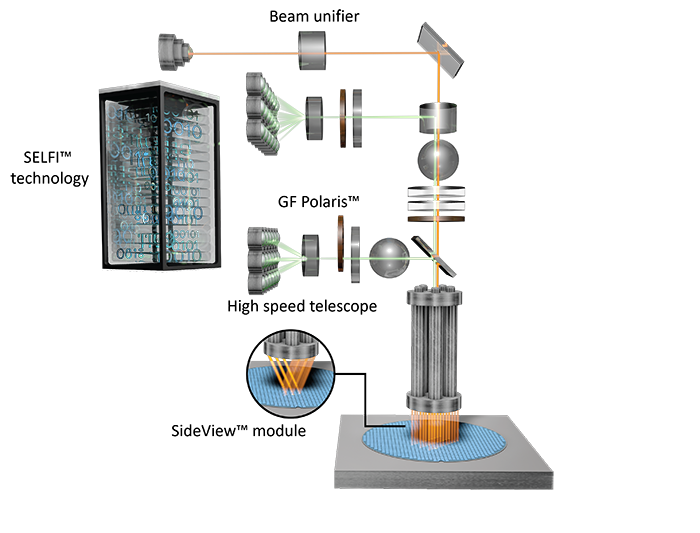
- 1 / 3
- 2 / 3
- 3 / 3
