Back to Menu
Enlight® Optical Inspection

반도체 설계 및 공정의 복잡성이 증가함에 따라 팹 비용이 급격히 높아졌습니다. 비용 증가로 인해 웨이퍼 제조 과정에서 진행되는 검사 단계의 수가 제한적입니다. 그러나 첨단 트랜지스터의 형상 크기가 극도로 작아 수율에 악영향을 주는 결함이 노이즈와 거의 구별되지 않으며, 작은 차이가 축적되어 3D 구조물을 제조하고 복잡한 멀티 패터닝 단계를 수행할 때 수율에 악영향을 주는 결함이 발생할 수 있습니다. 이러한 당면 과제는 검사를 더 자주 해야 한다는 점을 시사합니다.
Enlight Optical Inspection 시스템은 공정 관리를 혁신하기 위해 어플라이드에서 개발한 새로운 시스템입니다. 칩 제조사는 이 시스템을 사용해 검사에 필수적인 극한의 감도를 달성하고, 더 자주 검사를 수행하며, 더 많은 데이터를 수집하고, 생산을 가속화하며, 웨이퍼당 비용을 낮출 수 있습니다. 이 시스템은 업계 최고 수준의 고해상도-고속 검사 기술을 결합한 장비로서, 첨단 광학 기술을 통해 스캔당 더 많은 데이터를 수집합니다. 시스템의 고유 아키텍처는 고해상도 스캔과 웨이퍼 노이즈를 억제하는 고유한 3D 편광 제어 기능을 구현하기 위해 시장에서 가장 높은 NA를 갖춘 광학 시스템을 가지고 있습니다. 이 시스템은 또한 한 시스템 안에서 brightfield("BF") 및 grayfield("GF") 채널을 동시에 갖추고 다양한 이미지 컴퓨팅을 지원하는 유일한 시스템입니다. 이러한 모든 기능을 통해 생산 중에 고품질의 빅데이터를 생성할 수 있습니다.
Enlight 시스템은 빅데이터를 생성하여 치명적인 결함을 포착하는 데 투입되는 비용을 3배 절감할 수 있습니다. 칩 제조사는 이처럼 낮은 비용으로 제조 과정에서 검사 단계의 수를 늘리고 신속하고 정확하게 근본 원인을 파악할 수 있습니다. 또한 빅데이터를 사용하여 적시에 불량을 예측 및 감지하기 위해 라인 모니터링을 수행할 수도 있습니다.
어플라이드의 필수 요소로 자리 잡은 혁신적인 ExtractAI™ 기술은 Enlight 시스템의 빅데이터와 함께 작동하여 검사 과정에서 가장 어려운 당면 과제를 해결해줍니다. 즉 수율에 악영향을 미치는 결함과 불필요한 노이즈를 구별하도록 도와줍니다. ExtractAI는 머신 러닝과 통계 처리 알고리즘을 사용하여 고유한 방식으로 Enlight 시스템과 시장을 선도하는 어플라이드의 eBeam 검사 리뷰 및 결함 분류 시스템인 SEMVision®을 실시간으로 연결합니다. 이 기술은 SEMVision 시스템의 가이드를 받아, Enlight 검사장비에서 전달된 잠재 결함들의 단지 0.001% 수준의 리뷰만으로도 웨이퍼에서 대부분의 중요 결함을 추출할 수 있는 매우 효율적인 기술입니다. ExtractAI는 웨이퍼가 연속적으로 공정 처리되면서 실시간으로 학습하여 완전히 분류되고 노이즈가 없는 웨이퍼 결함 맵을 더욱 더 신속하고 빠르게 만들어냅니다.
어플라이드의 Enlight Optical Inspection과 ExtractAI 기술, SEMVision eBeam 검사 리뷰 기능을 결합하면 팹에서 이전보다 빠르게 더 많은 실행 가능 데이터를 받고 운용 비용을 낮추며 반도체 디바이스의 생산 및 출시 시간을 단축할 수 있습니다.

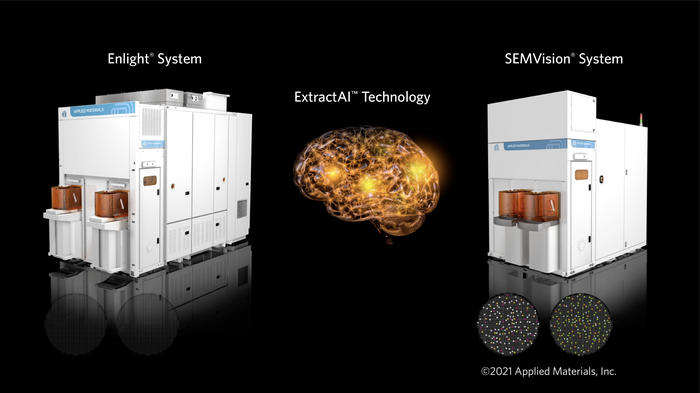
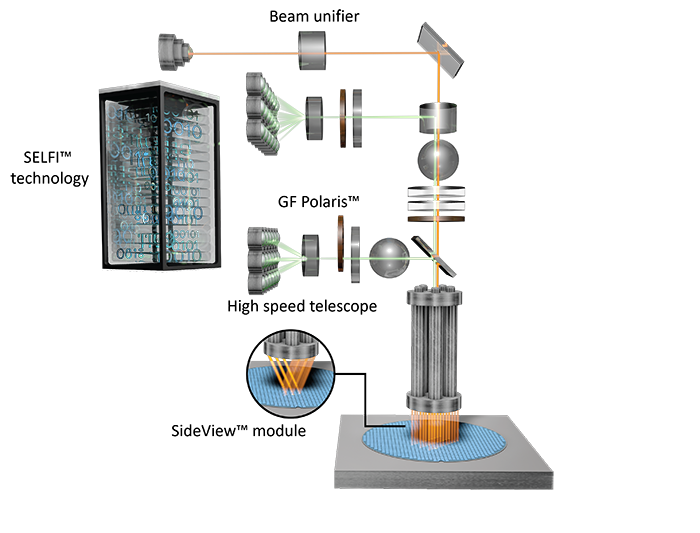
- 1 / 3
- 2 / 3
- 3 / 3
