Enlight™ 光学检测系统

半导体设计和工艺日渐复杂,导致晶圆厂成本飙升。此外,日益上升的成本等因素限制了晶圆生产流程中检测工序的数量。先进晶体管的特征尺寸极小,导致几乎无法从噪音中辨别影响良率的缺陷。在制造 3D 结构和实施复杂的多重图形工艺时,微小的偏差可能积聚,从而产生影响良率的致命缺陷。所有这些挑战都表明,需要加大检测频度。
Enlight 光学检测系统是应用材料公司工艺控制重塑方案的一个组成部分,使芯片制造商能够达到所需的极高检测灵敏度、更频繁地检测、收集更多的数据、提高良率、降低单位晶圆成本。该系统把领先业界的速度与高分辨率及先进光学扫描技术(每次扫描能收集更多的数据)相结合。其独特的架构具有市面上最大的数值孔径,可实现高分辨率扫描和独特的 3D 偏振控制,从而抑制晶圆噪音。它还是唯一具有同步明场和灰场检测通道及灵活图像计算功能的系统。所有这些功能可实现在生产过程中生成优质的大数据。
通过生成大数据,Enlight 系统使关键缺陷的采集成本降低三倍。成本的下降,让芯片制造商能够增加晶圆制造过程中的检测工序数量,同时还能快速准确地明确根本原因。大数据还让芯片制造商能实施在线监控,及时预测和检测偏差。
应用材料公司的突破性技术 ExtractAI™ 是其方案中不可或缺的组成要素,它与 Enlight 系统的大数据功能相配合,可解决缺陷检测中面临的最艰巨挑战:从噪音中识别影响良率的致命缺陷。ExtractAI 利用机器学习和统计处理算法,独特地在 Enlight 系统与应用材料公司享誉业内的电子束检视分类系统 SEMVision™ 之间建立了实时连接。这种技术特别高效,它可引导 SEMVision 逐一检视小至 0.001% 的潜在缺陷,从而提取晶圆上的所有相关缺陷。在源源不断的晶圆处理过程中,ExtractAI 实时学习,越来越快地创建完全分类且彻底无噪音的晶圆缺陷图。
晶圆制造厂采用应用材料公司的 Enlight 光学检测、ExtractAI 技术和 SEMVision 电子束检视能力,能够比以往更快速地获得更多的可执行数据,从而降低成本、提升良率、缩短产品上市时间。

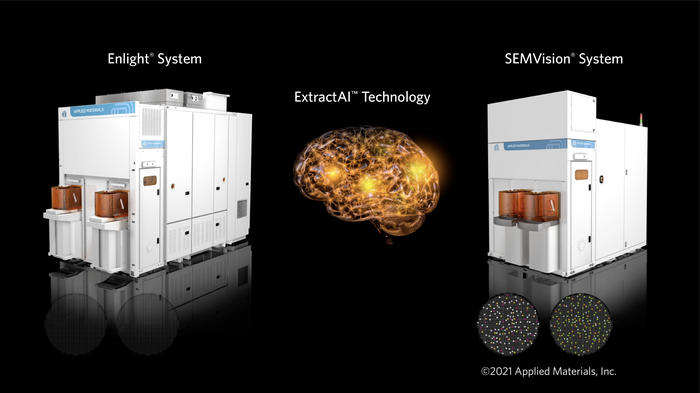
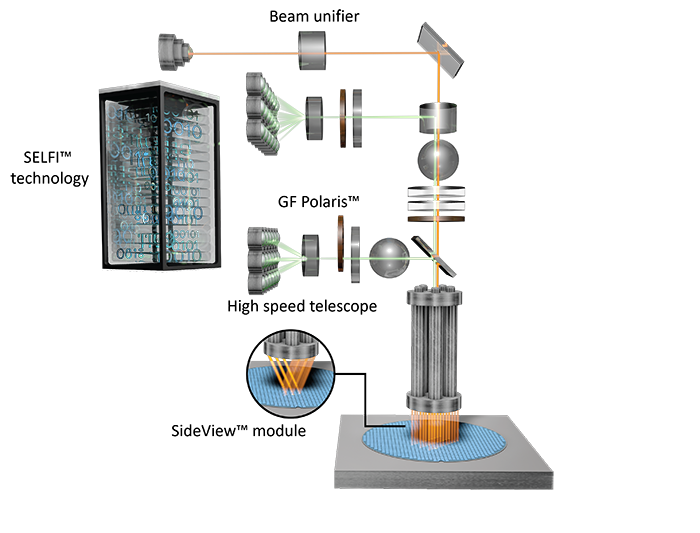
- 1 / 3
- 2 / 3
- 3 / 3
