Back to Menu
製品情報
Enlight® 光学ウェーハ検査装置
光学ウェーハ検査装置Enlightは、プロセスコントロールに向けたアプライド マテリアルズの新しい取り組みの一つで、これにより半導体メーカーは、要求される最高の検査感度、検査頻度、データ収集量を達成して歩留まりを向上させ、1ウェーハスキャンあたりのコストを削減できるようになります。業界トップクラスの処理速度と、高解像度、先進的光学機器を組み合わせ、1回のスキャンでより多くのデータを収集できます。独自のアーキテクチャを採用し、高解像度のスキャンを実現する市場最高水準の高NA(numerical aperture:開口数)と、ウェーハノイズを抑制する独自の3次元偏光制御を備えています。また、ブライトフィールドとグレイフィールド の同時検出チャンネルを持つ唯一のシステムで、柔軟な画像処理が可能です。これらすべての機能により、製造ラインでの高品質なビッグデータの生成が可能になります。
Enlightシステムは、ビッグデータの生成により、致命的欠陥の検出コストを3分の1に抑えます。CoO(Cost of Ownership)が削減できるため、半導体メーカーは製造工程により多くの検査ステップを増やして、迅速かつ正確な原因究明を行うことができます。さらに、ビッグデータの活用により、タイムリーな エクスカーションの予測・検出のためのラインモニタリングが可能になります。
アプライド マテリアルズの取り組みに欠かせないのが、画期的なExtractAI™テクノロジーで、Enlightシステムのビッグデータと連携することによりウェーハ検査で最も困難な課題を解決します。それは、歩留まりキラー欠陥とノイズを区別することです。ExtractAIテクノロジーは、機械学習と統計処理アルゴリズムを用いて、Enlightシステムと市場をリードするアプライド マテリアルズの電子ビームレビュー・分類装置SEMVision®との間をリアルタイムで接続します。ExtractAIテクノロジーはきわめて効率性が高く、SEMVisionを欠陥ごとにガイドした後、潜在的な欠陥のわずか0.001Xを介して、ウェーハ上のすべての必要な欠陥を抽出できます。ExtractAIはリアルタイムで学習し、連続して処理されるウェーハに対し、完全に分類され、徹底的にノイズを除去したウェーハ欠陥マップを順次作成します。
アプライド マテリアルズの光学ウェーハ検査装置Enlight、ExtractAIテクノロジー、電子ビームレビュー装置SEMVision を組み合わせることにより、半導体工場ではより多くの実用的なデータをこれまでになく迅速に入手することができ、CoOを削減して歩留まりを向上し、市場投入までの期間を短縮することができます。

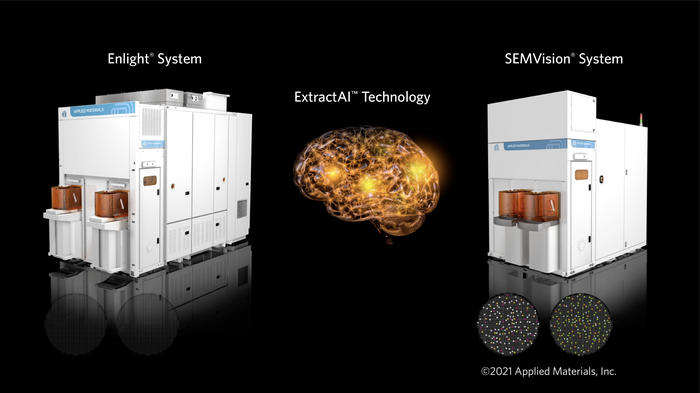
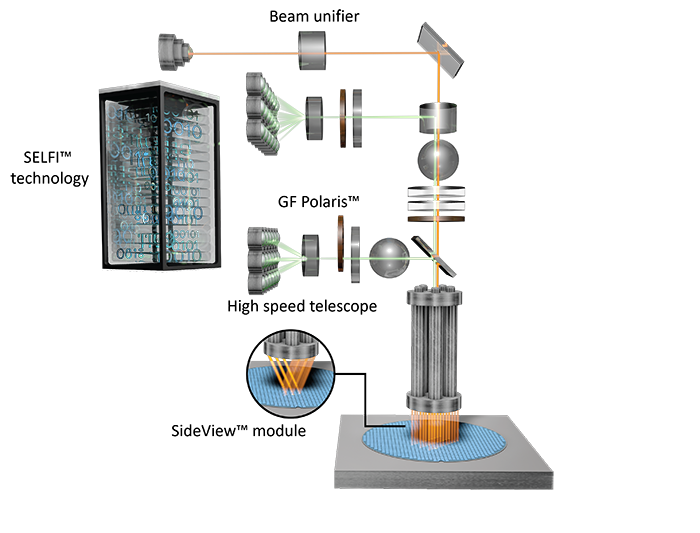
- 1 / 3
- 2 / 3
- 3 / 3

