半導體 (Semiconductor)
Endura® Volta® Cobalt CVD

採用均勻 CVD 鈷襯薄層和選擇性鈷覆蓋來封裝銅 導線,以提高 2Xnm 以下節點的可靠性與可擴展性。c
應用材料公司的 Endura Volta CVD Cobalt 系統使公司能夠在CVD 領域保持技術領先地位,在超過 15 年的銅阻擋層/晶種層 (CuBS) 開發中首次改變材料,以實現持續的高效能互連微縮。這種史無前例的技術可以沉積厚度不足 20Å 的晶種增強型襯層和選擇性覆蓋層,從而改善 2Xnm 及以下節點的互連線良率與可靠性。這是業界唯一基於真空的電遷移 (EM) 解決方案,是在同一平台上與預清洗、阻擋層和銅晶種層製程整合的唯一 CVD 鈷襯層產品。
在複雜移動技術需求的推動下,多組件系統晶片 (SoC) 設計在迅速激增,以便實現所需的功能和緊湊的形狀係數。而當代處理器偏於激進的節距微縮,進一步推動了電路密度的增加,而且對高效能導線必不可少,這些導線在多層元件中路徑長度近乎幾英哩。這些趨勢使實現元件運行所必需的覆蓋、粘附和無縫隙銅導線填充更具挑戰性。即便出現一個孔洞,也可能導致晶片的某些部分不可用。
Volta CVD Cobalt 系統為擴展銅導線技術推出新材料,將這項製程帶入新時代。它通過改善銅浸潤來促進銅晶種層覆蓋,並能夠形成便於修復不連續形貌和形成堅固晶種層的連續均勻薄層。這種高品質層進而能夠在最先進的節點下促進無縫隙銅填充。
此外,尺寸收縮會造成更高的電阻,而且更容易受到銅線路中電遷移失效的影響。銅與介電質阻擋層之間在界面層處的高質量接合,對避免電遷移失效至關重要。Volta 系統絕佳的 (>100:1) 選擇性金屬覆蓋製程可強化銅介電質界面層處的粘附,進而能夠成數量級提升電遷移效能,而不會增加線路電阻,也不會削弱時變性的介電擊穿特性。
Volta CVD Cobalt 同時用於襯墊層和選擇性金屬覆蓋製程,便於完全封裝銅線路,確保 2Xnm 及以下節點最堅固的互連可靠性。
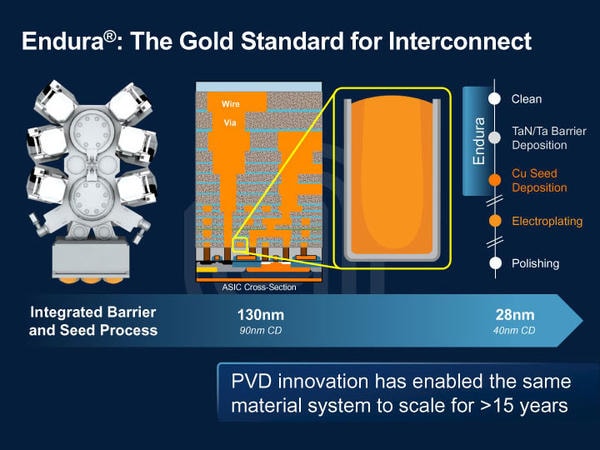



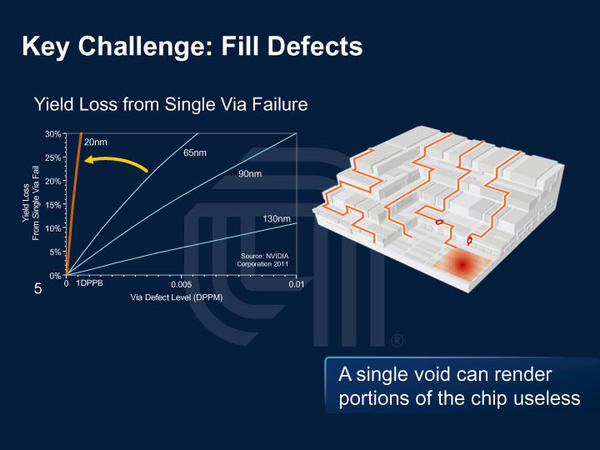





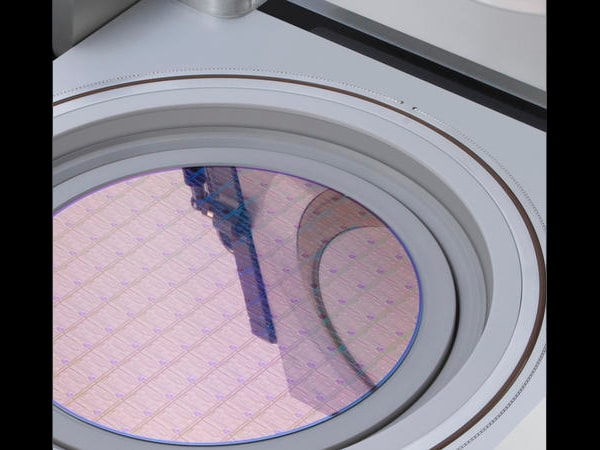


- 1 / 13
- 2 / 13
- 3 / 13
- 4 / 13
- 5 / 13
- 6 / 13
- 7 / 13
- 8 / 13
- 9 / 13
- 10 / 13
- 11 / 13
- 12 / 13
- 13 / 13

CVD 鈷晶種增強型襯層可促進堅固晶種層的形成,⏎將無孔洞銅間隙填充擴展到 20nm 以下節點。
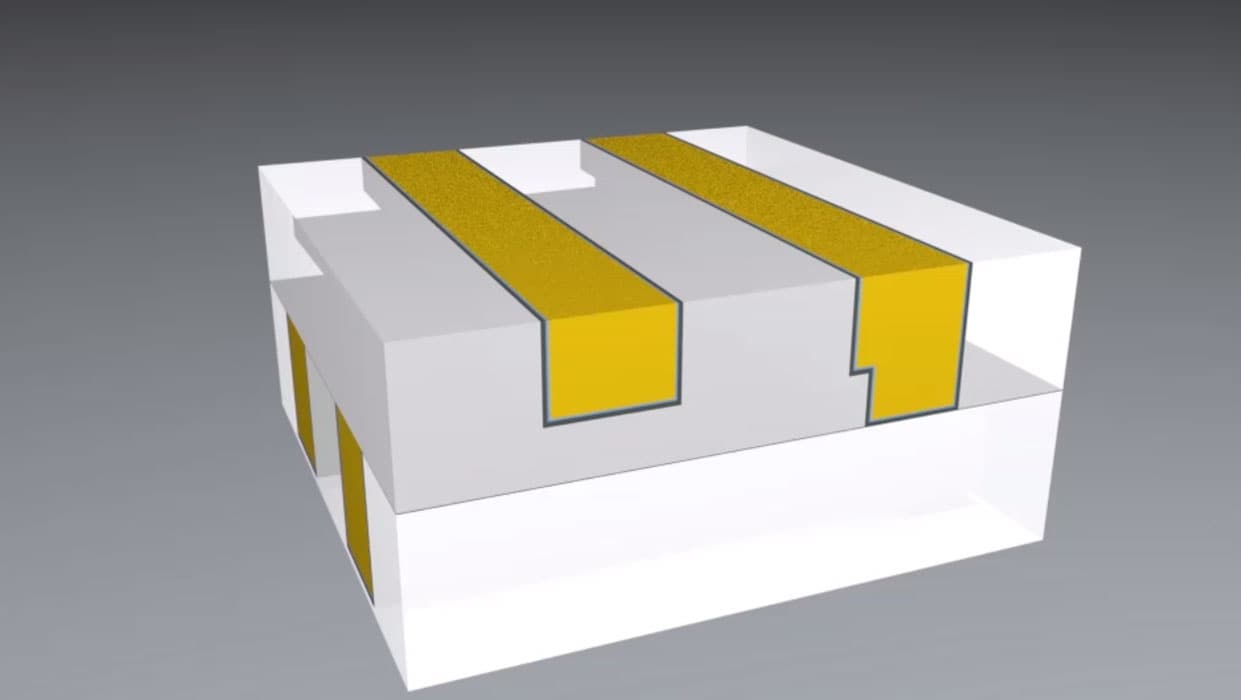
CVD 選擇性金屬覆蓋製程可強化銅與電介質的粘附,提高可靠性 ,而不會增加線路電阻,也不會削弱介電質層時變擊穿特性。
