Endura® Volta® Cobalt CVD

얇은 정합 CVD 코발트 라이너와 선적 코발트 피복층이 코발트 인터커넥트를 캡슐화해서 2Xnm 이하의 노드에서 신뢰성과 미세화를 향상시킵니다.
Endura Volta CVD Cobalt 시스템은 어플라이드가 CVD 분야에서 확립한 기술적 리더십을 이어오고 있습니다. 15년 넘게 이루어진 구리 베리어층/시드층(CuBS) 발전 과정속에서, 지속적인 고성능 인터커넥트 미세화를 구현하기 위해 최초로 물질 변경을 도입하였습니다. 이 최초의 기술은 시드층 강화 라이너(Seed-enhancing Liner)와 선택적 캡층(Cap Layer)을 20Å 미만의 두께로 증착할 수 있어, 인터커넥트 수율을 향상시키고 2Xnm 이하의 노드에서 신뢰성을 더욱 높입니다. 업계 유일의 진공 기반 엘렉트로마이그레이션(EM) 경감 솔루션이며, CVD 코발트 라이너 제품 중 유일하게 동일한 플랫폼 내에서 전세정, 베리어층 공정, 구리시드 층 공정을 수행합니다.
복잡한 모바일 기술에 대한 요구에 따라 개발된 다중 컴포넌트 시스템 온 칩(SoC) 설계는 원하는 기능과 소형화를 구현하기 위해 많이 활용되고 있습니다. 이러한 첨단 프로세서를 위한 공격적 미세화로 인해 이러한 멀티 레벨 소자에서 길이가 몇 마일에 달하는 인터커넥트에서 더 높은 회로 밀도와 고성능이 요구되고 있습니다. 이러한 흐름은 소자 작동을 위해 반드시 필요한 공극 없는 구리 인터커넥트를 만들어내는 피복성, 접착성, 충진의 달성을 더욱 어렵게 만들고 있습니다. 공극이 하나라도 있으면 칩의 일부분이 쓸모없게 될 수 있습니다.
Volta CVD Cobalt 시스템은 구리 인터커넥트 기술을 확장하기 위한 신소재 시대를 인도합니다. 구리 웨팅(wetting)을 향상시켜 구리 시드층 피복성을 높이기 때문에 얇고 연속적인 정합층을 생성할 수 있고 불연속 부위를 쉽게 리페어하고 견고한 시드층을 만들 수 있습니다. 이러한 고품질의 층은 최첨단 노드에서 공극 없는 구리 갭 충진을 가능하게 만듭니다.
또한 형상 구조 미세화로 인해 구리 라인의 저항이 더 높아지고 EM 불량 위험이 더 높아집니다. EM 불량을 피하려면 구리와 유전체 차단층 사이의 경계면에서 고품질의 본딩을 형성하는 것이 필수입니다. Volta 시스템은 동급 최고의(>100:1) 선택비를 가진 금속 피복 공정으로 구리-유전체 경계면의 접착력을 강화해서 라인 저항을 높이거나 시간에 따른 유전체 절연 파괴 특성을 약화시키지 않고 EM 성능을 수십 배 이상 향상시킵니다.
Volta CVD Cobalt를 라이너와 선택적 금속 피복 재료로 복합적으로 사용하면 구리 라인을 완벽하게 캡슐화하고 2Xnm 이하의 노드에서 가장 견고한 인터커넥트를 구현할 수 있습니다.
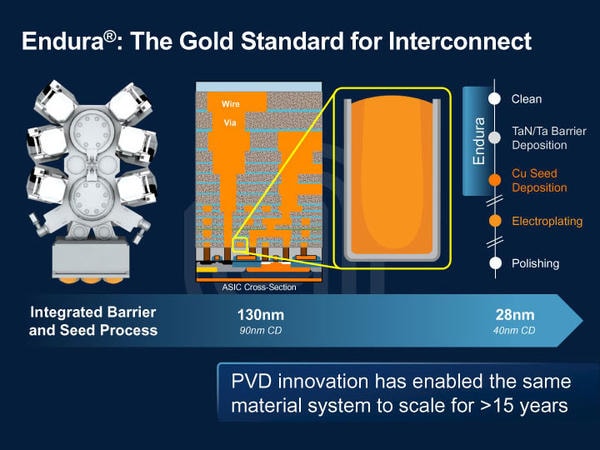



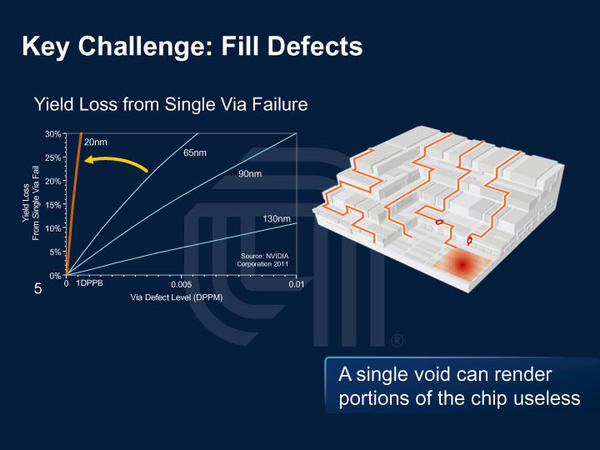





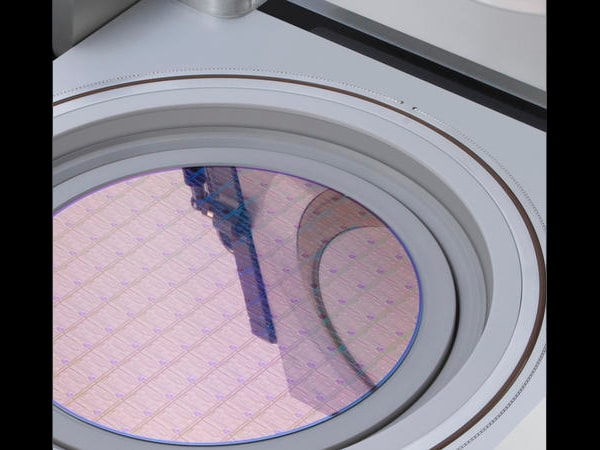


- 1 / 13
- 2 / 13
- 3 / 13
- 4 / 13
- 5 / 13
- 6 / 13
- 7 / 13
- 8 / 13
- 9 / 13
- 10 / 13
- 11 / 13
- 12 / 13
- 13 / 13

CVD 코발트 시드층 구현 라이너는 견고한 시드층 형성을 촉진해서 공극 없는 갭 충진을 20nm 이하의 노드로 확장합니다.
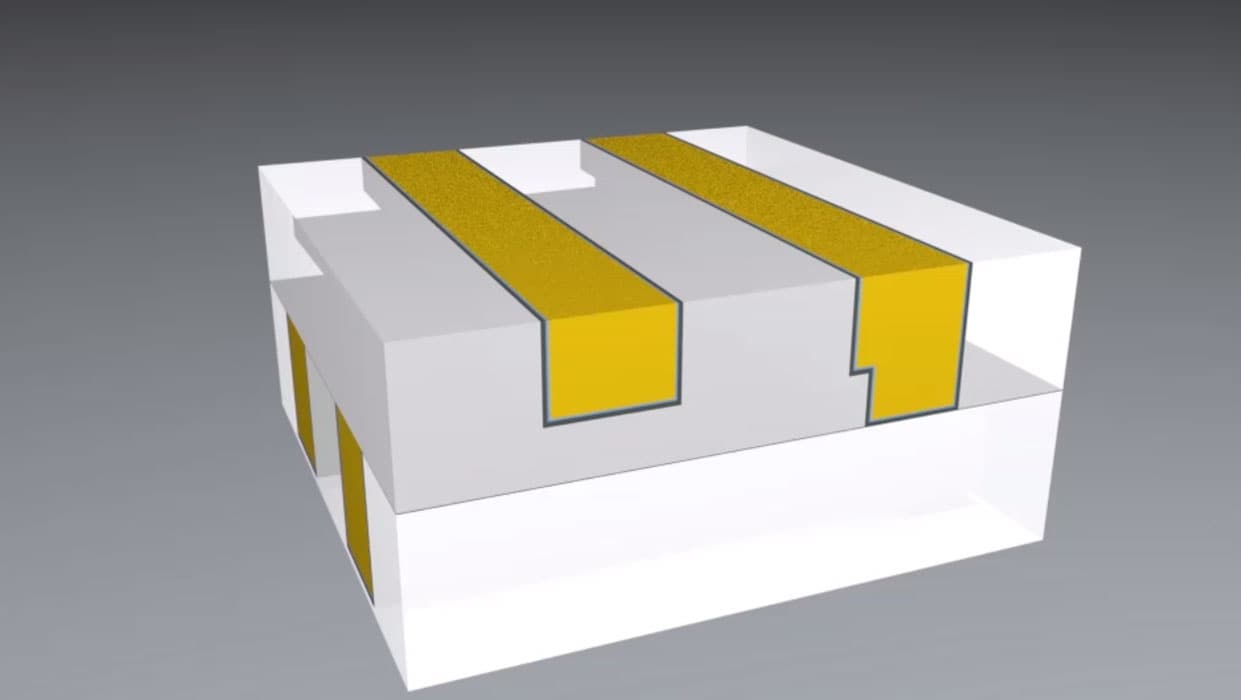
CVD 선별적 금속 피복 공정은 라인 저항을 높이거나 시간에 따른 유전체 절연 파괴 특성을 약화시키지 않으면서 구리-유전체 접착력을 강화하고 신뢰성을 향상시킵니다.
