半导体 (Semiconductor)
解决方案与软件
Endura™ Volta™ Cobalt CVD

采用薄的共形 CVD 钴衬层和选择性钴盖帽来封装铜互连层,以提高 2Xnm 以下节点的可靠性与可扩展性。
应用材料公司的 Endura Volta CVD Cobalt 系统使公司能够在 CVD 领域保持技术领先地位,在超过 15 年的铜阻挡层/种子层 (CuBS) 开发中首次改变材料,以实现持续的高性能互连微缩。这种史无前例的技术可以沉积厚度不足 20Å 的种子增强型衬层和选择性盖帽层,从而改善 2Xnm 及以下节点的互连线良率与可靠性。它是业界唯一基于真空的电迁移 (EM) 解决方案,是在同一平台上与预清洗、阻挡层和铜种子层工艺集成的唯一 CVD 钴衬层产品。
在复杂移动技术需求的推动下,多组件系统芯片 (SoC) 设计在迅速激增,以便实现所需的功能和紧凑的形状系数。而当代处理器偏于激进的节距微缩,进一步推动了电路密度的增加,而且对高性能互连线必不可少(这些互连线在多层器件中路径长度近乎几英里)。这些趋势使实现器件运行所必需的覆盖、粘附和无空隙铜互连线填充更具挑战性。即便出现一个孔洞,也可能导致芯片的某些部分不可用。
Volta CVD Cobalt 系统为扩展铜互连技术推出新材料,将这一工艺带入新时代。它通过改善铜浸润来促进铜种子层覆盖,从而能够形成便于修复不连续形貌和形成健壮种子层的连续薄共形层。这种高品质层进而能够在最先进的节点下促进无孔洞铜间隙填充。
此外,尺寸收缩会造成更高的电阻,而且更容易受到铜线路中电迁移失效的影响。铜与介电质阻挡层之间在界面层处的高质量接合,对避免电迁移失效至关重要。Volta 系统一流的 (>100:1) 选择性金属盖帽工艺可强化铜介电质界面层处的粘附,从而能够成数量级提升电迁移性能,而不会增加线路电阻,也不会削弱介电质层时变击穿特性。
Volta CVD Cobalt 同时用于衬里和选择性金属盖帽工艺,便于完全封装铜线路,确保 2Xnm 及以下节点最稳健的互连可靠性。
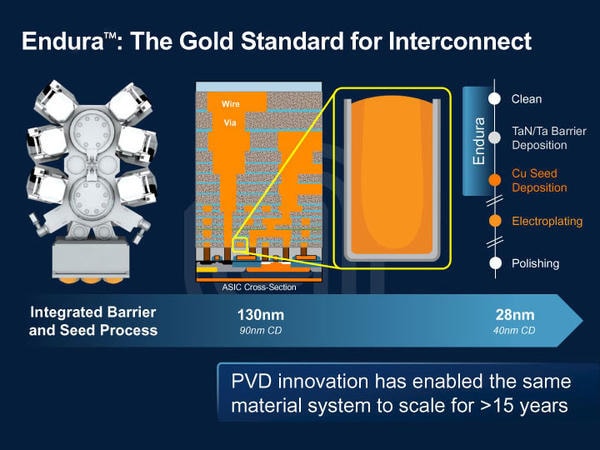



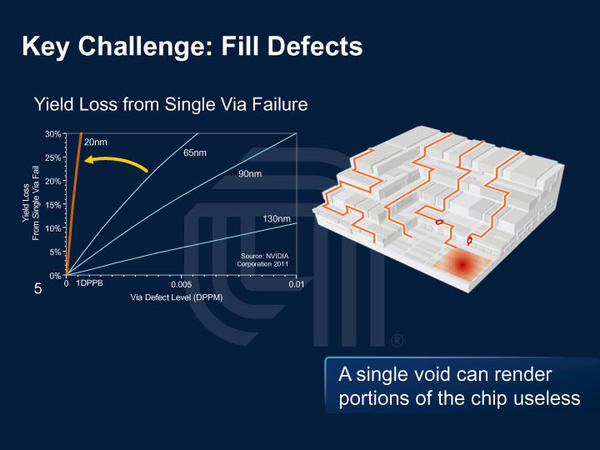





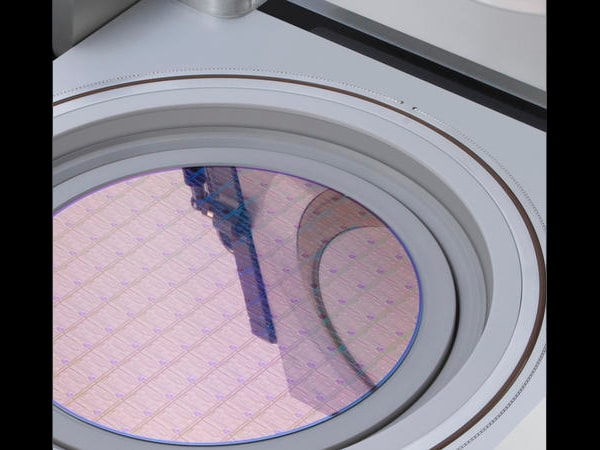


- 1 / 13
- 2 / 13
- 3 / 13
- 4 / 13
- 5 / 13
- 6 / 13
- 7 / 13
- 8 / 13
- 9 / 13
- 10 / 13
- 11 / 13
- 12 / 13
- 13 / 13

CVD 钴种子增强衬层可促进健壮的种子层的形成,将无孔洞铜间隙填充扩展到 20nm 以下节点。
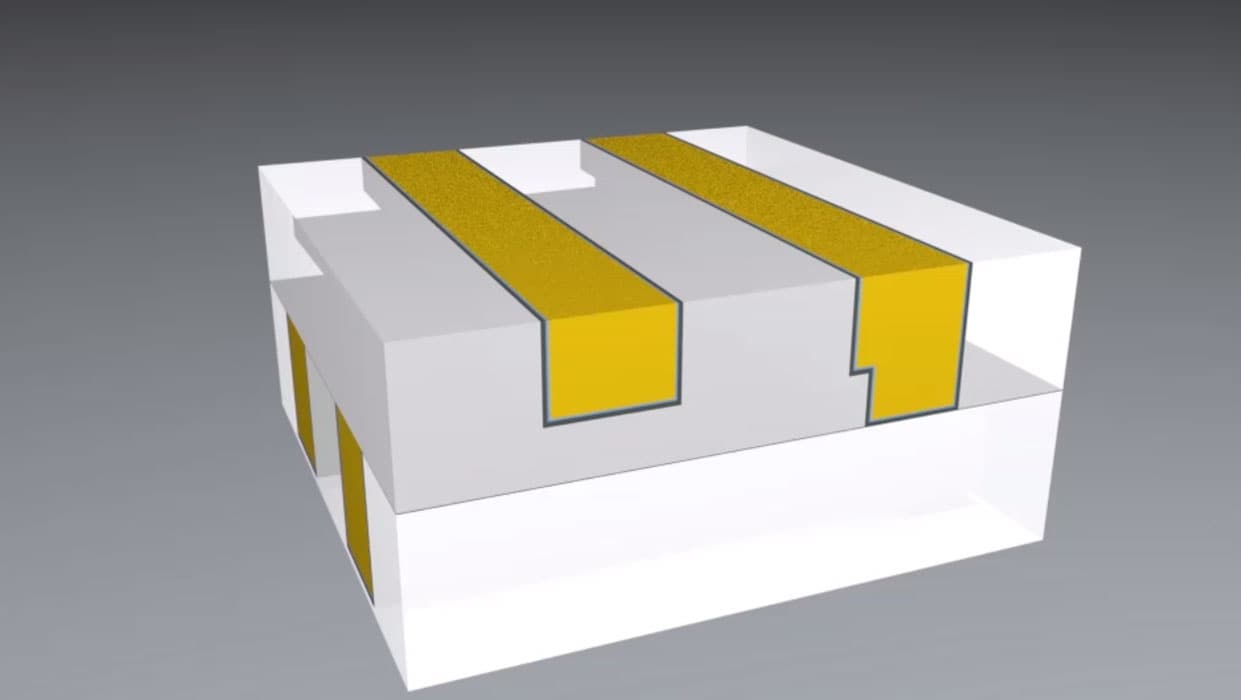
CVD 选择性金属盖帽工艺可强化铜与电介质的粘附,提高可靠性, 而不会增加线路电阻,也不会削弱电介质层时变击穿特性。
