Endura® Volta® Cobalt CVD

薄く、均一性の高いCVDコバルトライナーと選択的なコバルトキャップは、銅配線を封入し、2Xnm以降のノードにおける信頼性と拡張性を改善します。
Applied Endura Volta CVD Cobaltシステム は、継続的な高性能配線のスケーリングを可能にするため、15年以上に及ぶ銅バリア/シード(CuBS)開発において、初めて材料の変更をもたらし、CVDにおけるアプライド マテリアルズのリーダーシップの維持に貢献しています。同様のテクノロジーにおいて初めて、2Xnmノード以降の配線の歩留まりおよび信頼性を改善する、シード強化ライナーと20Å以下の選択制キャップ層の成膜を可能にしました。同システムは、業界で唯一の真空ベースのエレクトロマイグレーション(EM)対策ソリューションで、プリクリーンバリア、銅シードプロセスと同じプラットフォームに統合された、唯一のCVDコバルトライナー製品です。
複雑なモバイルテクノロジーからの要求に牽引され、必要とされる性能およびコンパクトなフォームファクタを提供するため、複数部品のシステム・オン・チップ(SoC)デザインが急増しています。これら最新のプロセッサ向けの積極的なピッチのスケーリングは結果として、より高密度な回路や、これらのマルチレベルデバイスを文字通り、何マイルにもおよび走る高性能な配線の必要性を牽引しています。これらのトレンドは、デバイスの動作に不可欠なボイドフリーの銅配線、カバレージ、接着、充填の達成をより困難なものにしています。たったひとつのボイドがチップの一部を使い物にならなくする可能性があります。
Volta CVD Cobaltシステムは、銅配線テクノロジーを拡張する新材料の時代をもたらします。同装置は、銅湿式法を改善することで、銅シード層のカバレージを促進し、薄く、継続的に均一性の高い層を生成し、不均一性の修復を促して強固なシード層を形成します。この高品質な層は結果として、最先端のノードにおいてボイドフリーのギャップフィルを促進します。
ジオメトリの縮小はまた、より高い抵抗と同時に銅線内のEM不良への感受性を高めることになります。銅と絶縁バリア層の界面における高品質な接着は、EM不良の回避に不可欠です。Voltaシステムのクラス最高(100:1以上)の選択的メタルキャッピングプロセスは、ライン抵抗や経時的な絶縁層の損傷を増加させることなく、桁違いにEM性能を改善するために、銅と絶縁層界面の接着を強化します。
ライナーと選択的メタルキャップ両方にVolta CVD Cobaltを使用することにより、銅線の完全な封入が可能になり、2Xnmノード以降で最も強固な配線の信頼性を確保します。
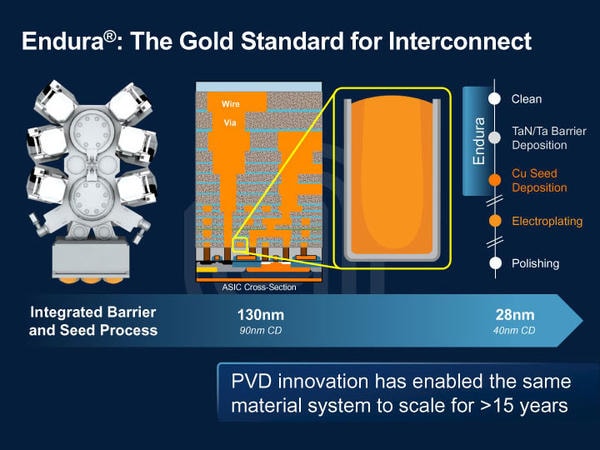



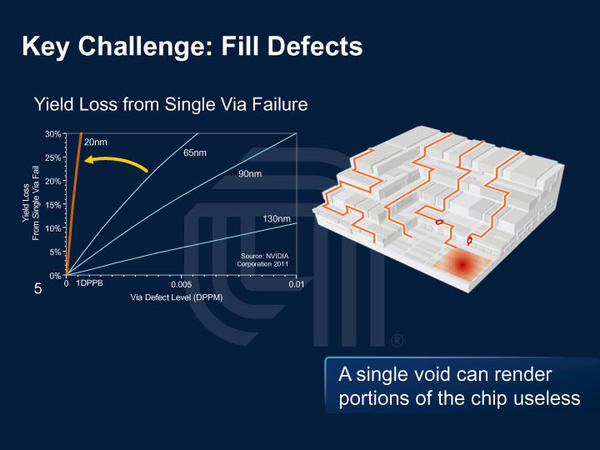





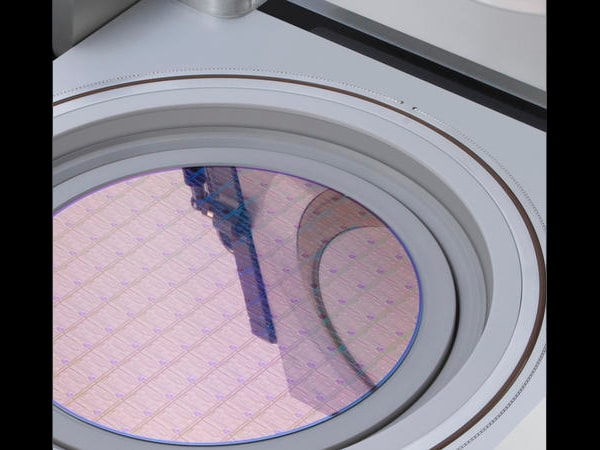


- 1 / 13
- 2 / 13
- 3 / 13
- 4 / 13
- 5 / 13
- 6 / 13
- 7 / 13
- 8 / 13
- 9 / 13
- 10 / 13
- 11 / 13
- 12 / 13
- 13 / 13

CVDコバルトシード強化ライナーは、強固なシード層の形成を促進し、20nm以降にボイドフリーの銅ギャップフィルを拡張しています。
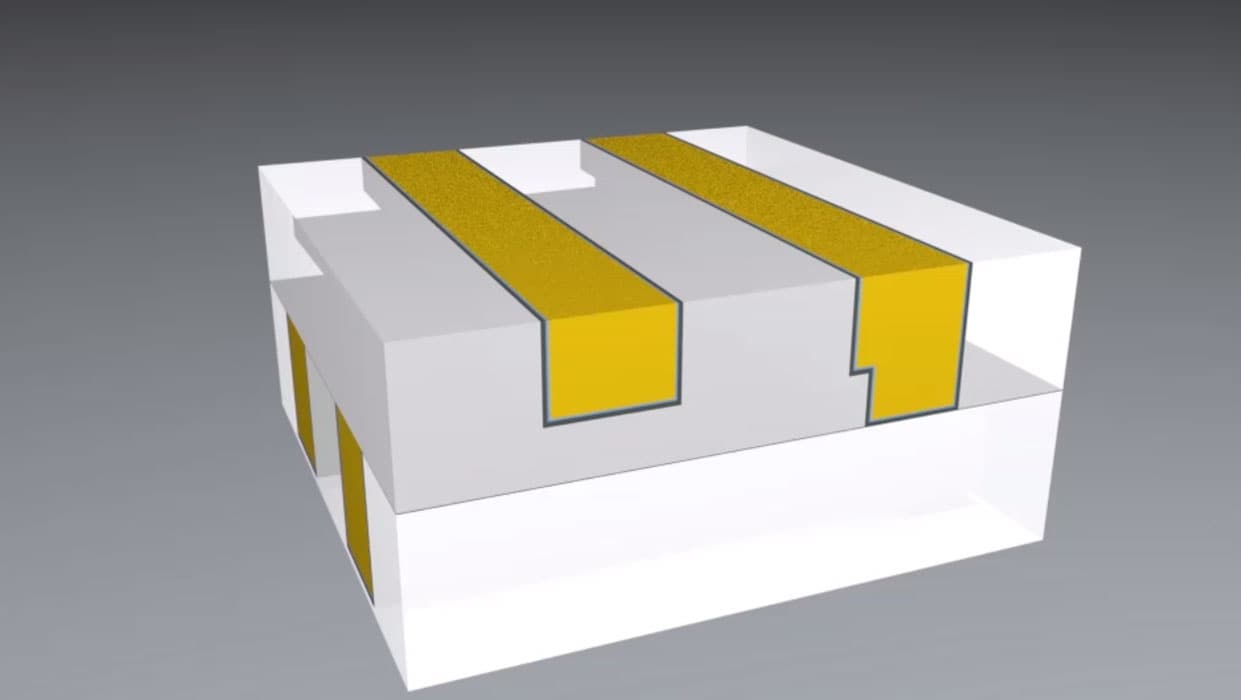
CVD選択的メタルキャッピングは、銅と絶縁層の接続を強化し、ライン抵抗や経時的な絶縁層の損傷を増加させることなく、信頼性を向上します。
