Producer® Selectra® Etch
Producer Selectra Etch システムは、斬新なエッチング技術により3D ロジックやメモリチップのさらなるスケーリングを実現してムーアの法則を推進します。Selectraの画期的なプロセスは、一層から多層膜に対して、かつてない選択性で特定材料のみを除去します。
チップ設計においてフィーチャーはますます小さく、アスペクト比は高くなり、先進の集積回路では、より高密度にパッケージされています。デバイスが精確にパターニングされ、クリーンであることは、究極の信頼性と性能を得る上で非常に重要です。不完全な異物の除去や、不適切な選択制による限界寸法(CD)の拡大は、デバイスの性能や歩留まりに悪影響を及ぼします。高アスペクト比のフィーチャーにおけるパターンの変形(ラインの屈折やパターンの崩れ)は、次世代デバイスの歩留まりにも影響を及ぼす可能性があります。
Selectra プロセスは、これらの問題をすべて解決します。独自のプロセスにより、先進の FinFET に対しては原子レベルで制御されたエッチングを行い、3D NAND の凹部を均質化し、高アスペクト比の DRAM 構造を傷めずにクリーニングすることができます。
同システムは、さまざまな絶縁体、金属、および半導体の膜を原子レベルの精密さで取り除く、調節可能な選択性を達成するために、ラジカルベースの化学薬品を採用しています。このテクノロジーは、今日の FinFET デバイスの限界を拡張し、未来のゲートオールアラウンド構造を可能にすることにより、ムーアの法則を推進し続ける中で重要な役割を担います。

従来の選択制の低いプロセスでは、 NANDスタックの下部よりも上部により多くのタングステンの凹部が形成され、デバイス性能の低下の原因となっていました。

ウェットエッチングの際、材料選択性が低いと、円筒形DRAMコンデンサのすべての層が広くなり、直径が大きくなってしまいます。
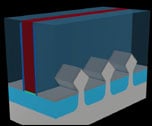
結晶面に依存したウェットエッチング工程では、先進のロジックトランジスタにおいて、隙間にポリシリコンの残渣が発生することがあります。

ウェットエッチング後の乾燥工程において、毛管力(スティクション)がアスペクト比の高い構造体の倒壊を引き起こします。

タングステン選択性により、Selectraプロセスでは3D NANDスタック全体で非常に均一な凹部エッチングを生成するように調整することができます。

Selectraプロセスは、円筒の直径を拡大したい特定の層だけに選択的に作用させることができます。
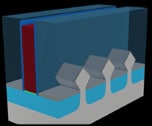
Selectraプロセスは、ポリシリコンの残渣をすべて取り除き、ゲート酸化膜の表面をクリーンで、次のメタルゲート成膜が可能な状態にします。

Selectraの完全にドライなプロセスでは、壊れやすい形状の構造が保全されます。




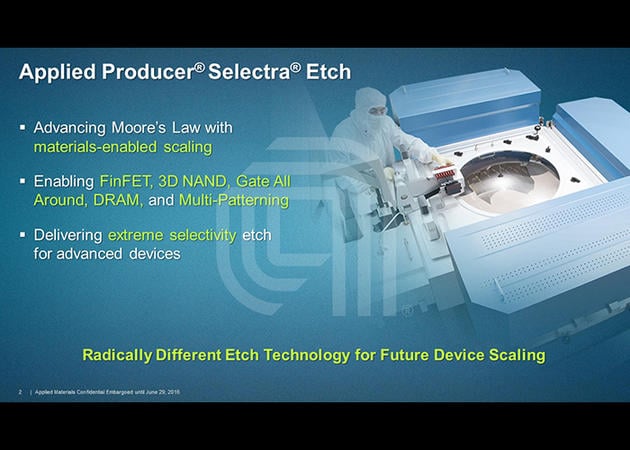
- 1 / 5
- 2 / 5
- 3 / 5
- 4 / 5
- 5 / 5

