-
ALD
-
CMP
-
CVD(化学气相沉积)
-
ECD
-
外延生长
-
刻蚀
-
离子注入
-
测量与检测
-
Pattern Shaping
-
光掩膜
-
PVD(物理气相沉积)
-
快速热处理(RTP)
-
模拟
-
化合物半导体
-
微机电系统(MEMS)
-
功率
Producer™ Selectra™ 刻蚀系统
Producer Selectra Etch 系统以前所未有的功能特性,进一步帮助缩减 3D 逻辑和存储芯片尺寸,从而延续摩尔定律的势头。该工艺可对一个或多个薄膜进行选择性刻蚀,以前所未有的选择比性能来除去特定材料。
在先进集成电路的芯片设计中,特征尺寸逐渐变小,深宽比变得更高,封装越来越密集。器件图形化或清洁的准确度,对最终器件的可靠性和性能至关重要。选择比不足所造成的材料去除不彻底和关键尺寸增加,对器件性能和成品率具有不利影响。高深宽比特征的图形变形(线路弯曲和图形损坏)也可能影响下一代器件的成品率。
Selectra 系统解决了所有这些问题。它独特的工艺能够实现先进 FinFET 的原子级刻蚀控制、均匀一致的 3D NAND 凹槽和高深宽比 DRAM 结构的无损清洁。
该系统采用自由基化合物来提供可调选择比,从而能够以原子级精度去除各种介电质、金属和半导体薄膜。该技术对于延伸当前的 FinFET 器件边界和支持未来的环栅结构来推进摩尔定律至关重要。

传统工艺的选择比不足,会导致 NAND 叠层顶部附近的钨凹陷大于底部,从而造成器件性能降低。

湿法刻蚀溶液的材料选择比不足,会导致DRAM电容的所有圆柱形相关材料层圆洞直径增加。
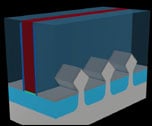
湿法刻蚀工艺的各向异性,会导致先进逻辑晶体管的空隙中残留多晶硅。

湿法刻蚀之后的干燥步骤受限于粘滞作用,会导致高深宽特征层的变形。

Selectra 工艺的钨选择比可进行调整,可在整个 3D NAND 叠层上形成极其均匀的刻蚀凹槽。

Selectra 工艺可进行调整,从而实现有选择性的作用于需要增大直径的圆洞层。
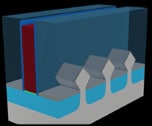
Selectra 工艺可去除所有多晶硅残留,使栅氧化物特征保持清洁,便于进行金属栅极沉积。

Selectra 的完全干法刻蚀工艺可使脆弱的特征层保持结构完整性。




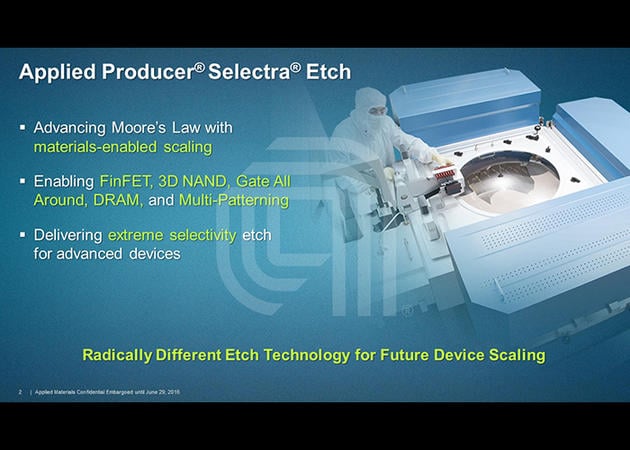
- 1 / 5
- 2 / 5
- 3 / 5
- 4 / 5
- 5 / 5

