Endura® Volta® W CVD
タングステンは、その低抵抗率とコンフォーマルなバルクフィル特性により、ロジックのコンタクト、MOL、メタルゲートフィルのアプリケーションで広く用いられています。コンタクトとローカル配線は、トランジスタと回路のその他の部品間の重要な電気通路を形成します。したがって、低抵抗率は、堅牢で信頼性の高いデバイス性能を実現する上で非常に重要です。しかし、微細化が進むにつれ、配線の寸法は最適なトランジスタ性能を実現する上でコンタクト抵抗が障害になるレベルまで 縮小しています。
配線断面が縮小すると、バリアメタルや核形成層が占める体積が増大し、導電性のメタルフィルの体積が減少します。また、プラグにメタル界面が追加されるたびコンタクト抵抗は悪化します。Volta CVD W装置は、特殊化学を用いWカーボン膜の成膜を可能にするチャンバへのハードウェア拡張で、このような悪影響を解消します。この独自の材料は、ライナー層としても核形成層としても使用できます。同材料は、誘電体に強力に接合し、後のバルク成膜工程におけるフッ素拡散を防止します。その抵抗率は、(例えばTiNなどの)標準的なライナーよりも70%以上低くなっています。また、この膜は、主としてWであるため、バルクWの核形成基板として動作します。したがって、界面膜の総膜厚は薄くなり、低抵抗なWフィルの体積が拡大します。
Volta CVD W膜は、限界寸法(CD)やプロセスフローによって異なりますが、コンタクト抵抗を最大90%低減します。これにより、デバイスの電力供給、性能、効率を向上し、次世代デバイスに向けてWのMOL配線プラグ適用範囲を拡張します。また、この低抵抗率により、与えられたテクノロジーノードで積極的に微細化が進められるようになり、より高密度なデバイス設計が可能になります。
詳細は、次にお問い合わせください。
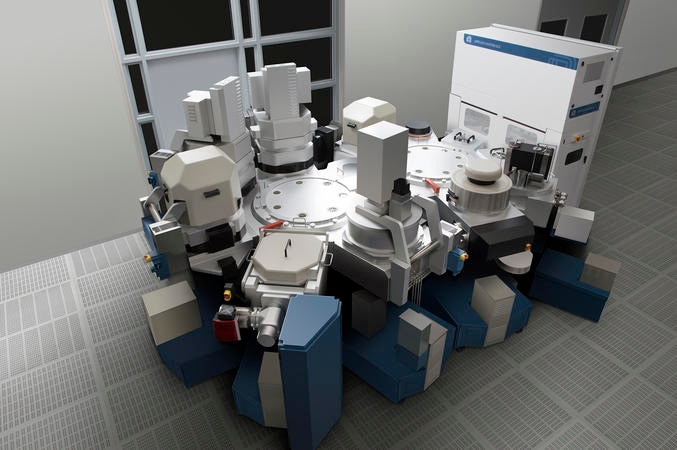
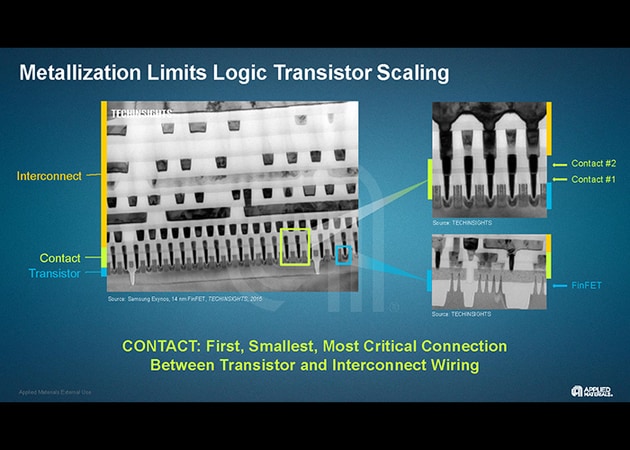

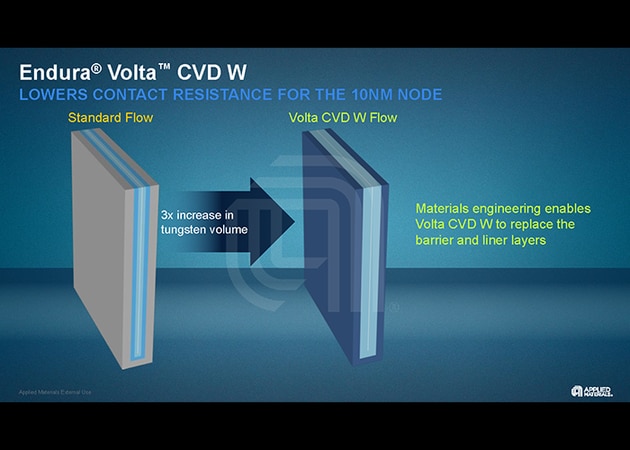
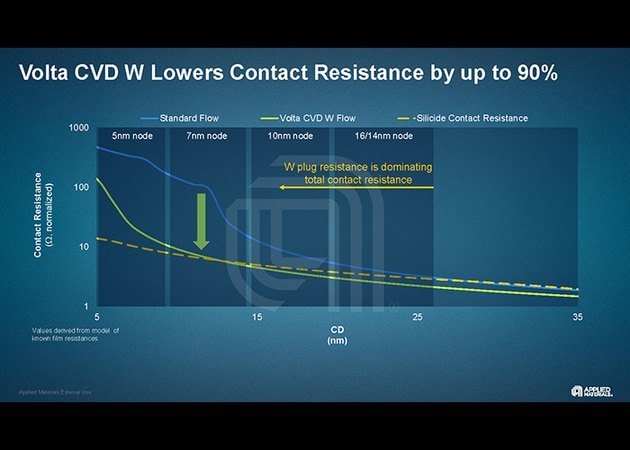
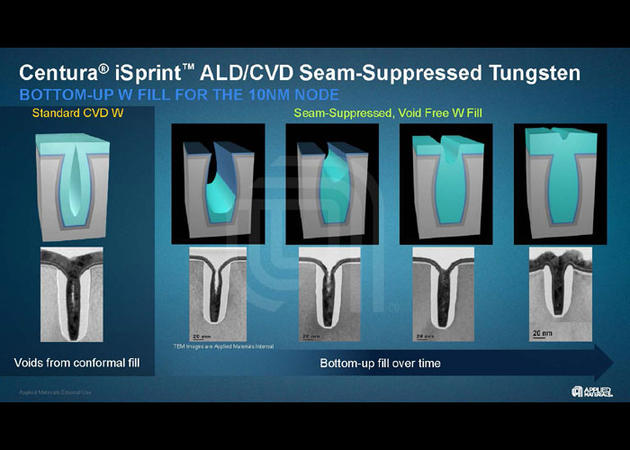

- 1 / 7
- 2 / 7
- 3 / 7
- 4 / 7
- 5 / 7
- 6 / 7
- 7 / 7
