半導体
市場と変化
ソリューションとソフトウェア
Centura iSprint SSW ALD/CVD
As semiconductor devices continue to scale to smaller dimensions and shift to new 3D structures, the challenge of metallizing contacts grows more complex. これらのコンタクトは、チップのある場所から別の場所へ電子を輸送し、デバイスの性能に不可欠です。何年もの間、従来の CVD タングステンは、その低い抵抗率とエレクトロマイグレーションに対する堅牢性から、これらの形状の多くをメタライズするプロセスと材料として選ばれていました。 しかし、アスペクト比の高い形状や、側壁が内側に凹んだオーバーハング形状では、従来のCVD技術で充填すると、シームやボイドが発生しやすくなります。
Centura™ iSprint™ ALD/CVD Seam Suppressed Tungsten (SSW)システムは、ピンチオフが発生する可能性のある位置でW成長を調節する処理プロセスを採用しています。 この技術により、タングステン金属のボトムエンハンスト成長が可能になります。 このユニークな成膜メカニズムにより、抵抗や歩留まりに悪影響を及ぼすシームやボイドの発生が抑制されます。SSWシステムの多用途性により、チップメーカーは、ロジックやメモリを含む複数のアプリケーションにわたる、要求の厳しいさまざまな形状のギャップフィル要件を満たすことができ、同時に大量生産で高い生産性を達成することができます。
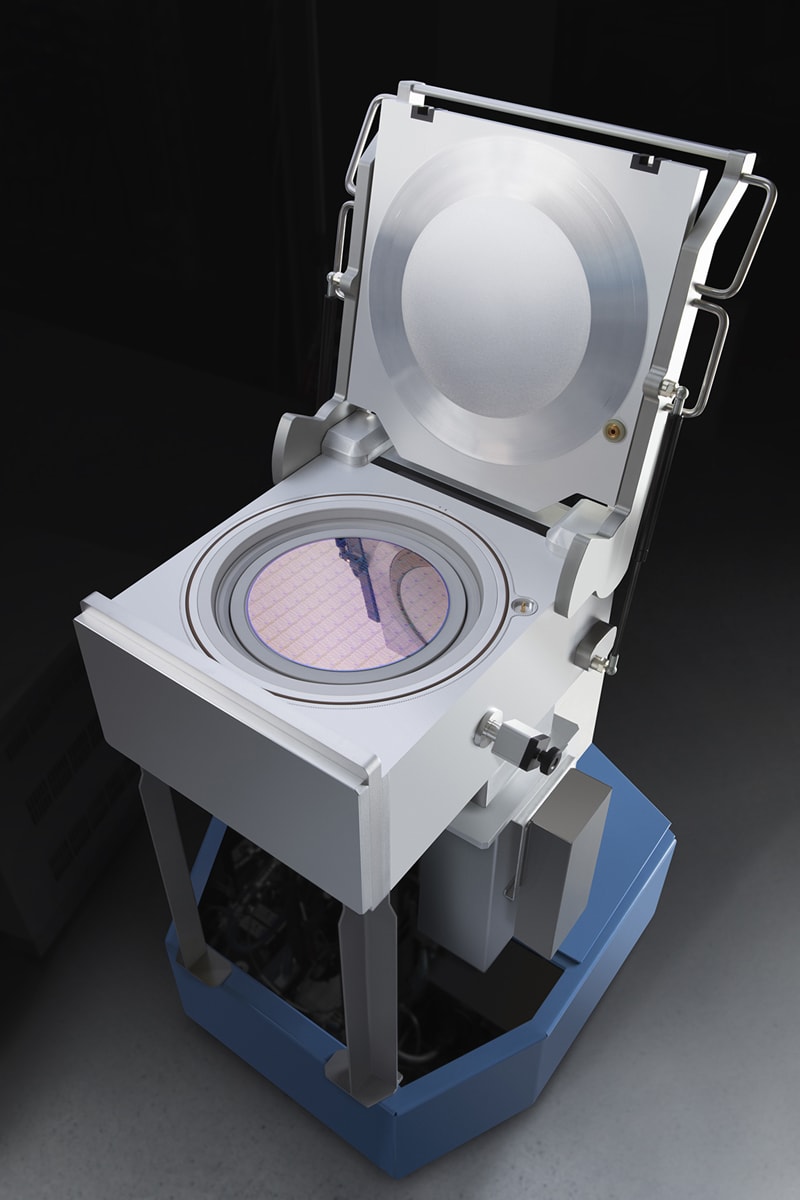
独自の処理プロセスを採用したCentura iSprint SSW ALD/CVDプロセスは、タングステンメタルのボトムエンハンスト成長を実現し、シームやボイドを抑制することで、より強固なギャップフィルを実現し、歩留まりを向上させます。
