半导体 (Semiconductor)
技术
-
ALD
-
CMP
-
CVD(化学气相沉积)
-
ECD
-
外延生长
-
刻蚀
-
离子注入
-
测量与检测
-
Pattern Shaping
-
光掩膜
-
PVD(物理气相沉积)
-
快速热处理(RTP)
-
模拟
-
化合物半导体
-
微机电系统(MEMS)
-
功率
晶圆制造厂环境解决方案
Endura™ Volta™ W CVD
钨已广泛用于逻辑接触体、中端和金属栅极填充应用中,因为它具有低电阻和保形批量填充性能。接触体和局部互连线在晶体管和其余的电路之间形成了临界电气通路。因此,低电阻率对于稳健和可靠的器件性能至关重要。然而,随着微缩继续进行,互联层尺寸开始缩小到某种程度,并成为实现最佳晶体管性能的障碍。
随着互联层的横截面继续减小,越来越多的体积被金属阻挡层和成核层占据,为导电金属填充所留的体积变小。此外,插塞中的每个额外的金属界面让接触电阻更糟糕。Volta CVD W 系统通过腔体的硬件增强功能来缓解这些不利因素,该腔体能够使用专业化学品来沉积 W 碳薄膜。这一独特的材料能够充当衬层和成核层。它可以强有力地粘合介电质,并可以避免在后续的大量沉积工艺中发生氟扩散。其电阻率比标准衬层(如 TiN)低 70%。此外,如果薄膜主要为 W 薄膜,它表现为批量 W 薄膜的成核基板。因此,界面膜的总厚度更薄,从而增加了可用于低电阻率 W 填充的体积。
根据关键尺寸和工艺流程,Volta CVD W 薄膜最高可将接触孔电阻降低 90%。因此,它改善了设备的功率输出、性能和效能,并为下一代器件扩展了 W 中端互联插塞。更低的电阻也便于在给定的节点中更激进地微缩,从而能够实现更高的器件密度。
点击此处了解更多信息。
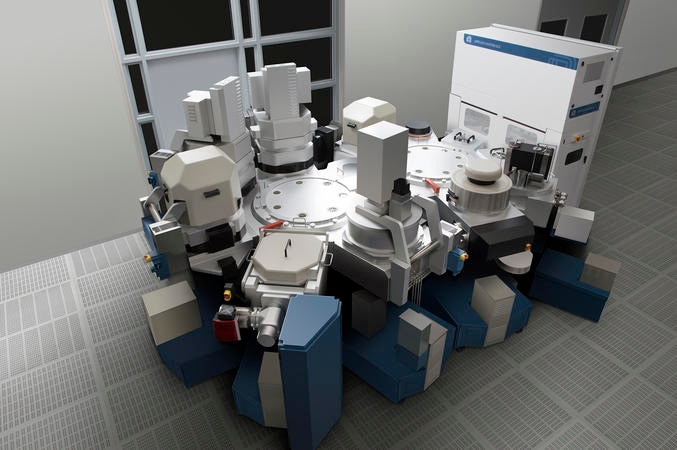
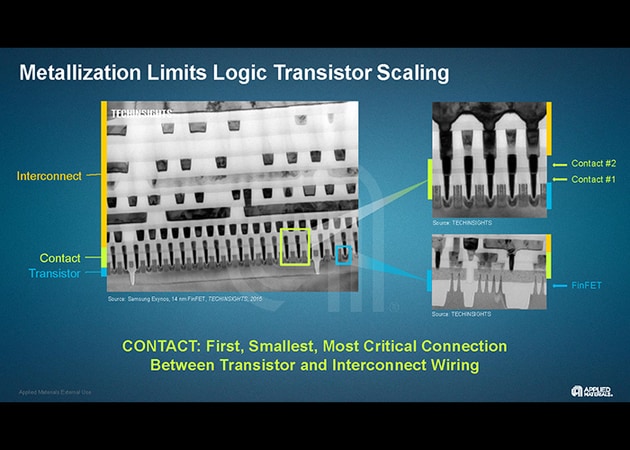

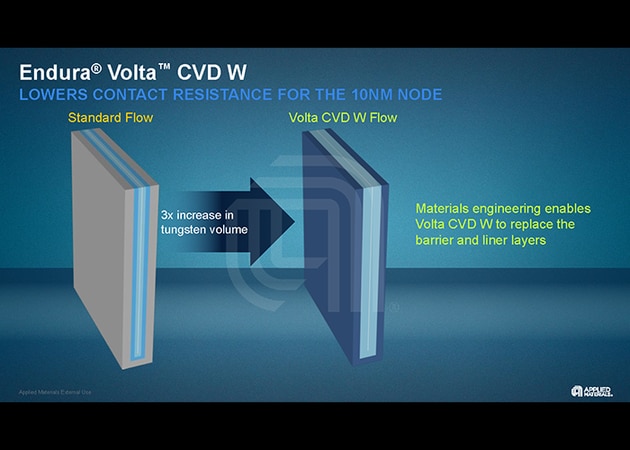
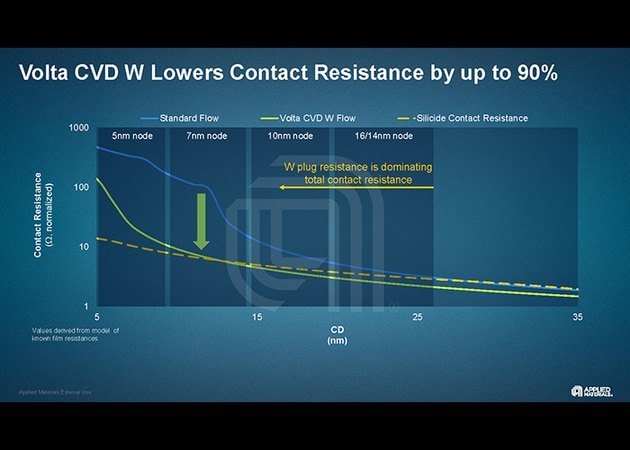
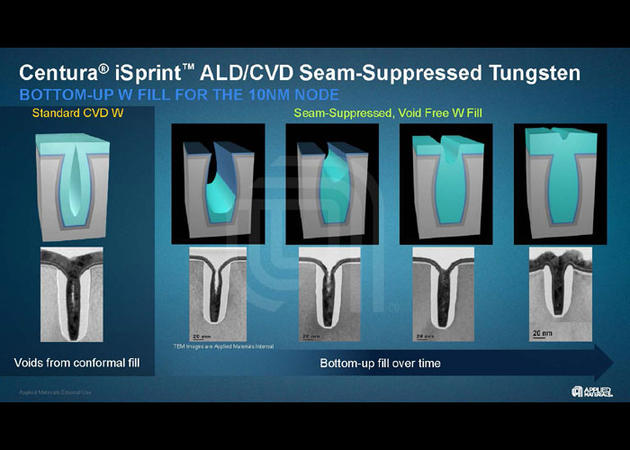

- 1 / 7
- 2 / 7
- 3 / 7
- 4 / 7
- 5 / 7
- 6 / 7
- 7 / 7
