半導體 (Semiconductor)
Endura® Volta® Selective W CVD
Applied Endura Volta Selective W CVD 系統提供了整合材料解決方案,以 2D 微縮的突破來減輕這些不利影響。該系統結合了表面處理室與選擇性鎢沉積室。選擇性沉積可以透過沉積室的獨特處理能力及各種表面處理來實現,這些表面處理利用具有針對性的化學方法來準備底層金屬和接點電介質,以實現由下而上的金屬對金屬沉積。選擇性製程去除了襯墊層/阻擋層與成核層,緩解了元件性能的瓶頸,帶來無孔洞和無接縫的間隙充填。
由於所有製程步驟均在超潔淨、連續的高真空環境中進行,因此整合材料解決方案可確保原始界面以及無缺陷的接點填充。相較於傳統襯墊層/阻擋層的接點製造方法,在最大化導電金屬體積的情況下,接點電阻率獲得顯著改善。這個較低的電阻有助於提高元件密度並延伸 2D 微縮。

在傳統的接點間隙充填過程中,
導電金屬體積受到襯墊層/阻擋層與成核層的限制。

選擇性鎢的導電體積
讓接點的整個體積可用於導電金屬。
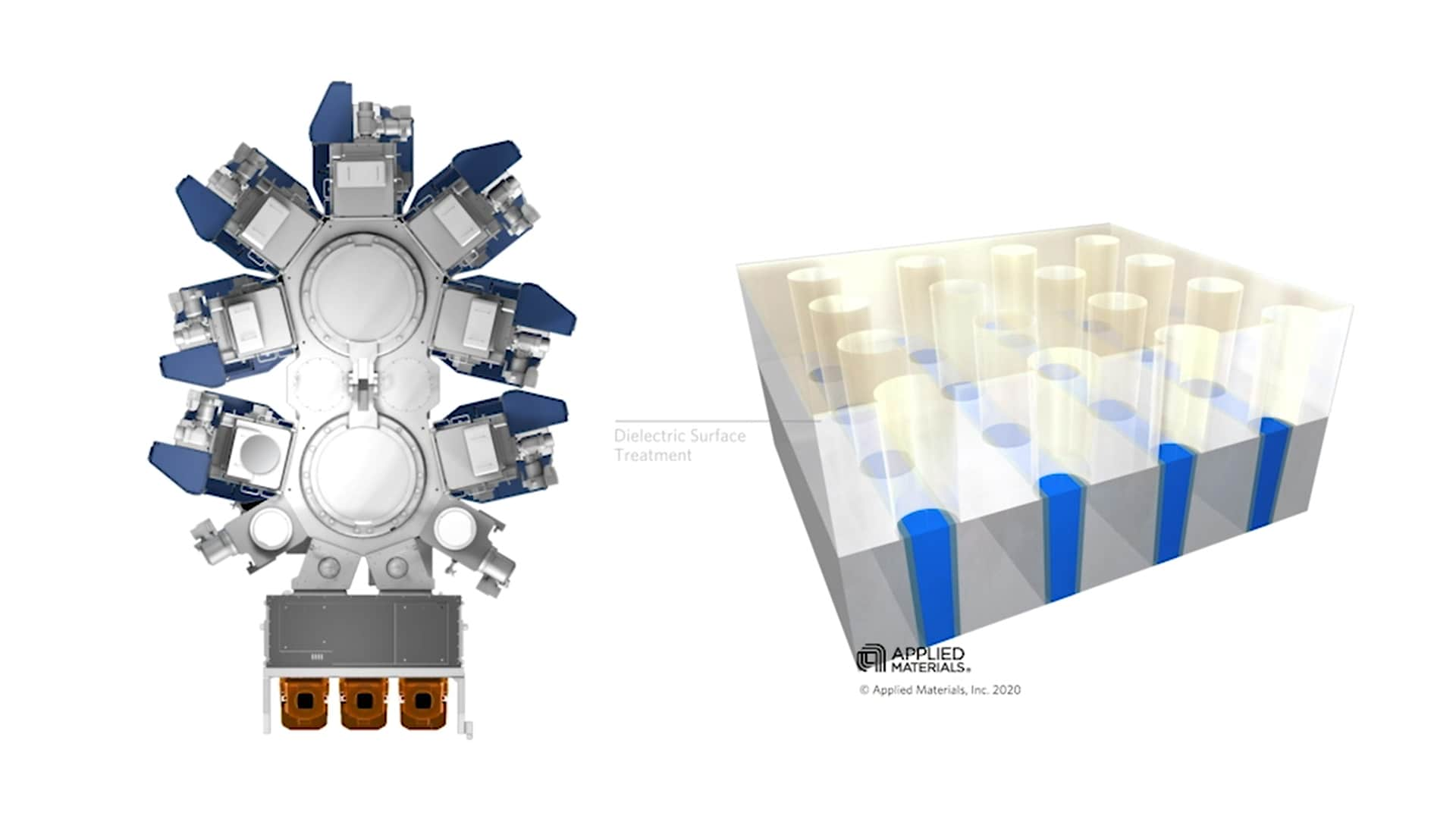
選擇性沉積法的整合材料解決方案結合了
表面針對性預處理與獨特的鎢沉積製程。

Applied Endura® Volta™ Selective W CVD 系統

