半导体 (Semiconductor)
技术
-
ALD
-
CMP
-
CVD(化学气相沉积)
-
ECD
-
外延生长
-
刻蚀
-
离子注入
-
测量与检测
-
Pattern Shaping
-
光掩膜
-
PVD(物理气相沉积)
-
快速热处理(RTP)
-
模拟
-
化合物半导体
-
微机电系统(MEMS)
-
功率
晶圆制造厂环境解决方案
Endura™ Volta™ 选择性钨化学气相沉积
应用材料公司的Endura Volta 选择性钨化学气相沉积 (Selective W CVD) 系统提供了一种集成材料解决方案(Integrated Materials Solution™),缓解了伴随二维微缩领域的突破带来的不利影响。该系统包括表面处理腔室与选择性钨沉积腔室。选择性沉积是通过沉积腔室的独特工艺能力和各种表面处理来实现的,这些表面处理使用专门的化学制剂来制备接触孔的底层金属和介电质,从而实现自底而上的金属对金属沉积。这种选择性工艺消除了衬垫/阻挡层和成核层,从而缓解了器件性能的瓶颈,并生成无空隙和无缝隙的填充。
由于所有的工序都是在超洁净、连续的高真空环境中进行,这种整合材料解决方案确保了纯净的界面和无缺陷的导线填充。与传统的衬垫/阻挡层导线制造相比,随着导电金属体积的最大化,导线电阻率得到了显著改善。这种较低的电阻率有利于提高器件密度并延伸了二维微缩。

在传统的导线间隙填充中,导电
金属的体积受衬垫/阻挡层和成核层的限制。

选择性钨沉积使整个导线的体积
都可用于导电金属。
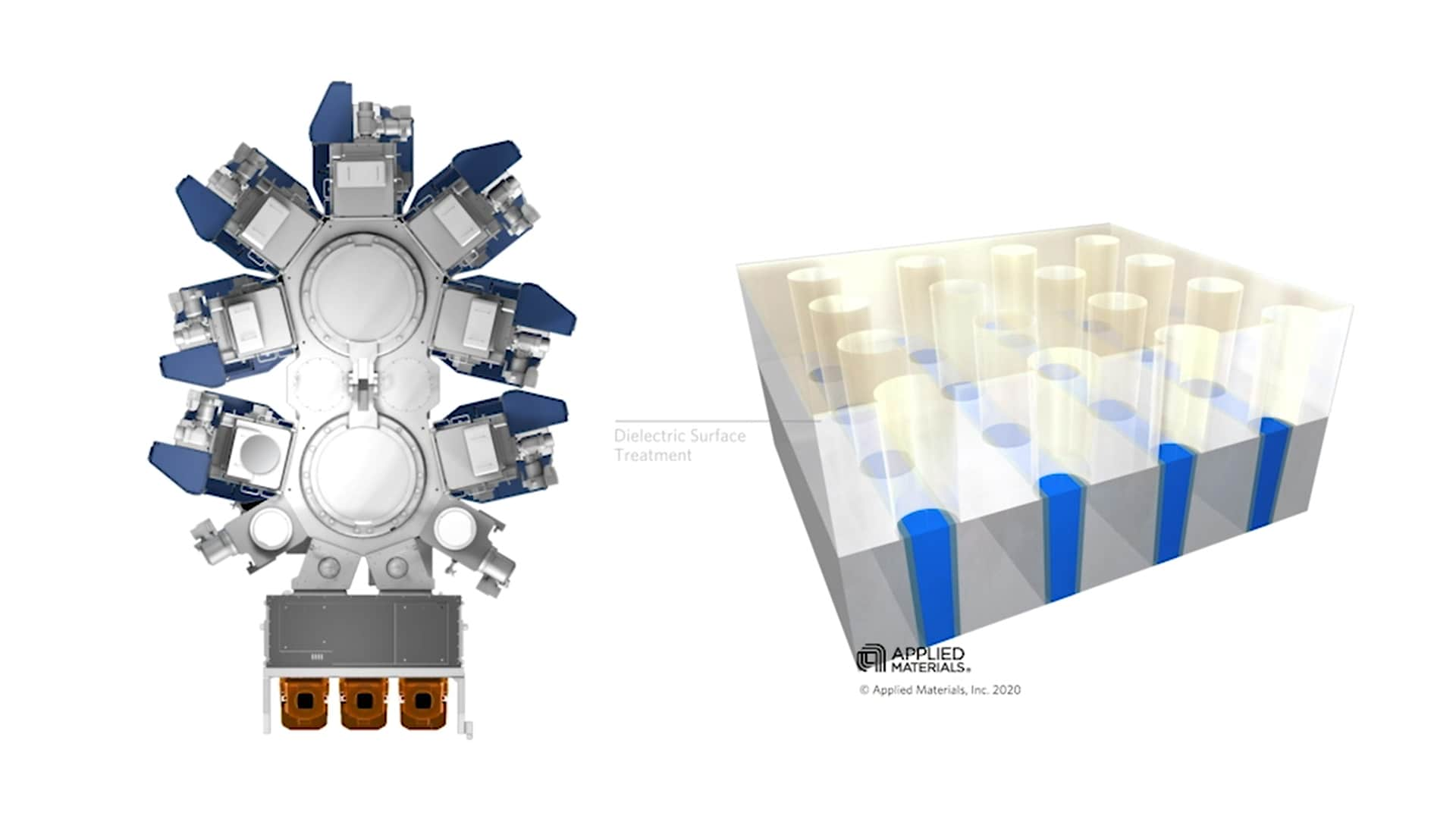
这种用于选择性沉积的集成材料解决方案结合
将专门的表面预处理与独特的钨沉积工艺相结合。

Endura™ Volta™ 选择性钨化学气相沉积系统

