半導體 (Semiconductor)
Endura® Ventura® PVD
隨著二維 (2D) 元件微縮達到物理和電氣極限,TSV 技術成為了一種向緊湊型、三維 (3D) 架構過渡的方法,在當前激增的移動技術中,該架構能夠以較低的功耗實現更快的性能和更強大的功能。TSV 技術使產品設計師能夠創建 3D 導電層連接,通過連接堆疊晶片或晶圓的垂直路徑將各個節點的電路元件相整合。
應用材料公司的 Endura Ventura PVD 系統專為TSV 金屬化而設計,是公司在物理氣相沉積 (PVD) 領域的最新創新,使客戶能夠將其 2D 鑲嵌積體基礎設施和專門技術擴展到深寬比 ≥10:1 的 TSV 和 2.5D 中介層應用。這也是首個針對 TSV 的 PVD 系統,可實現具有量產價值的鈦阻擋層沉積。針對後段製程 (BEOL) 應用的現有 PVD 系統並不是專為此類高深寬比 (HAR) 特徵而設計,這些系統需要高沉積率,以滿足生產效率要求,並實現無孔洞間隙填充和良好的可靠性。為確保間隙填充和元件可靠性所必需的連續階梯覆蓋,這些系統必須沉積相對較厚的層。除了成本更高以外,厚薄膜增加了可能降低最終良率的應力缺陷風險。
Ventura 系統可應對這些 TSV 挑戰,顯著降低了大規模採用這一技術的技術障礙與成本障礙。該系統採用了改進的離子密度、方向性和可調能量,以便在 HAR TSV 內部沉積比 BEOL 系統中的層薄 50% 的連續鉭或鈦阻擋層和銅晶種層,並大大降低了生產成本。較薄的薄膜與較高的沉積速率使 Ventura 系統的產能超過現有的 BEOL PVD 系統的一倍以上。
該系統使我們的客戶能夠加工他們所選擇的材料。儘管應用材料公司並不出售這些材料,但 Ventura 反應室可在 Endura 平台上與銅晶種層製程相整合,靈活處理鉭和鈦阻擋層。這兩種材料都展現出了高可靠性,但鈦具有更高的成本效益。
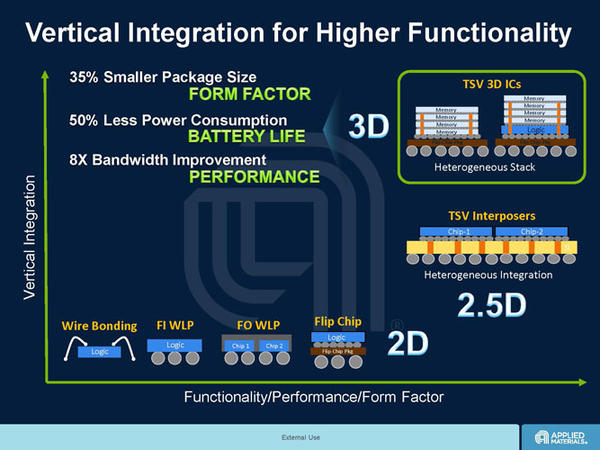


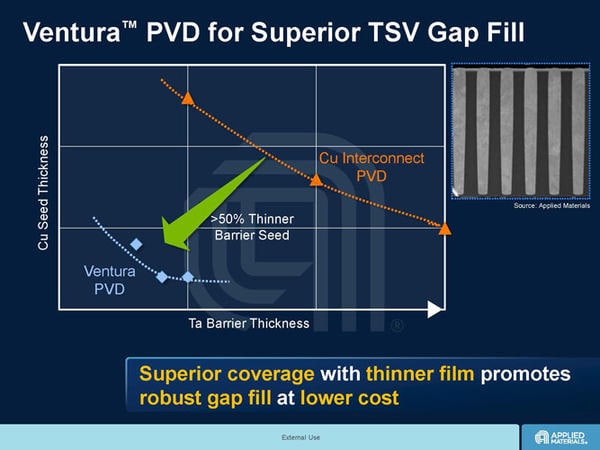



- 1 / 7
- 2 / 7
- 3 / 7
- 4 / 7
- 5 / 7
- 6 / 7
- 7 / 7
