半导体 (Semiconductor)
解决方案与软件
Endura™ Ventura™ PVD
随着二维 (2D) 器件微缩达到物理和电气极限,TSV 技术成为了一种向紧凑型、三维 (3D) 架构过渡的方法,在当前激增的移动技术中,该架构能够以较低的功耗实现更快的性能和更强大的功能。TSV 技术使产品设计师能够创建 3D 互连,通过连接堆叠芯片或晶圆的垂直路径将各个节点的电路元件相集成。
应用材料公司的 Endura Ventura PVD 系统专为 TSV 金属化而设计,是公司在物理气相沉积 (PVD) 领域的最新创新,使客户能够将其 2D 镶嵌集成基础设施和专门技术扩展到深宽比 ≥10:1 的 TSV 和 2.5D 中介层应用。它也是首个面向 TSV 的 PVD 系统,可实现具有量产价值的钛阻挡层沉积。面向后段制程 (BEOL) 应用的现有 PVD 系统并不是专为此类高深宽比 (HAR) 特征而设计,这些系统需要高沉积率,以满足生产效率的要求,并实现无孔洞间隙填充和良好的可靠性。为确保间隙填充和器件可靠性所必需的连续阶梯覆盖,这些系统必须沉积相对较厚的层。除了成本更高以外,厚薄膜增加了可能降低最终良率的应力缺陷风险。
Ventura 系统可应对这些 TSV 挑战,显著降低了大规模采用这一技术的技术与成本障碍。该系统采用了改进的离子密度、方向性和可调能量,以便在 HAR TSV 内部沉积比 BEOL 系统中的层薄 50% 的连续钽或钛阻挡层和铜种子层,并大大降低了生产成本。较薄的薄膜与较高的沉积速率使 Ventura 系统的产能超过现有的 BEOL PVD 系统的一倍以上。
该系统使我们的客户能够加工他们所选择的材料。尽管应用材料公司并不出售这些材料,但 Ventura 腔室可在 Endura 平台上与铜种子层工艺相集成,灵活处理钽和钛阻挡层。这两种材料都展现出了高可靠性,但钛具有更高的成本效益。
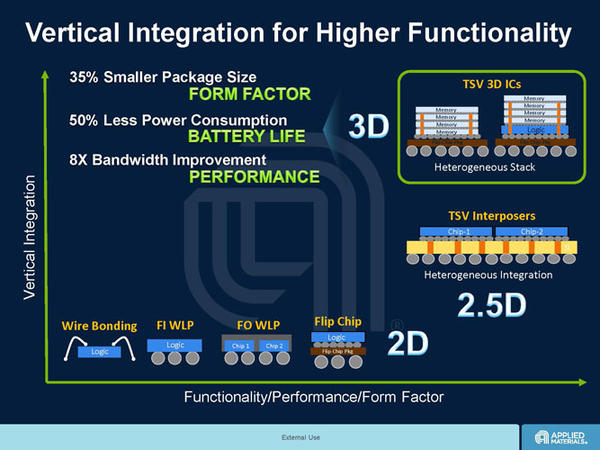


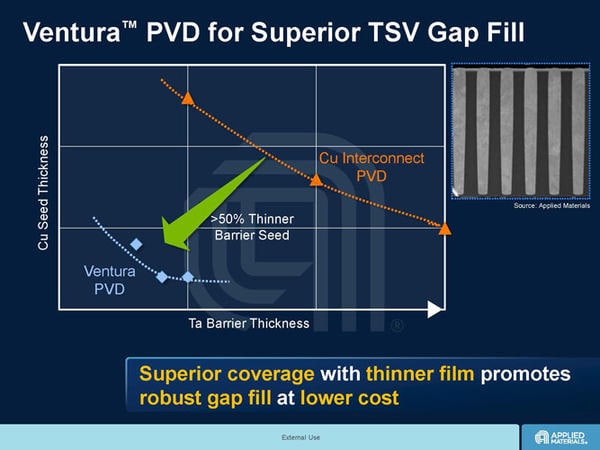



- 1 / 7
- 2 / 7
- 3 / 7
- 4 / 7
- 5 / 7
- 6 / 7
- 7 / 7
