Endura® Ventura® PVD
2차원(2D) 소자 미세화가 물리적, 전기적 한계에 도달하게 되면서 TSV 기술은 오늘날 크게 발전하고 있는 모바일 기술 분야에서 더 낮은 전력 소비량으로 더 빠른 성능과 더 우수한 기능을 가능하게 만드는 미세한 3차원(3D) 구조로 전환하기 위한 수단으로 활용되고 있습니다. TSV 기술을 사용해 제품을 설계하면 스택된 칩 또는 웨이퍼를 연결하는 수직 경로를 통해 여러 노드의 회로 소자를 통합하는 3D 인터커넥트를 만들 수 있습니다.
TSV 금속 배선 공정을 위해 특별히 설계된 어플라이드 Endura Ventura PVD 시스템은 물리 기상 증착(PVD) 분야의 최신 혁신 제품입니다. 고객은 이 시스템을 사용해 2D 다마신 공정 인프라와 노하우를 종횡비 ≥10:1인 2.5D 인터포저 응용 분야의 TSV로 확장할 수 있습니다. 또한 생산할 만한 가치가 있는 티타늄 차단층 증착을 제공하는 TSV를 위한 최초의 PVD 시스템입니다. 백엔드(BEOL) 응용 분야를 위한 기존의 PVD 시스템은 그러한 고종횡비(HAR) 형상을 위해 설계되지 않았습니다. 이러한 형상은 생산성 요건, 공극 없는 갭 충진, 우수한 신뢰성을 충족시키기 위해 높은 증착 속도가 요구됩니다. 이러한 시스템은 갭 충진과 소자 신뢰성을 위해 반드시 필요한 연속 스텝 커버리지를 보장하기 위해서 상대적으로 두꺼운 층을 증착해야 합니다. 두꺼운 필름은 비용이 더 들어갈 뿐만 아니라 최종 수율을 낮출 수 있는 응력 결함의 위험도 높입니다.
이러한 TSV 난관을 해결한 Ventura 시스템은 이 기술의 채택과 관련된 기술과 비용 측면의 문제를 크게 낮춥니다. HAR TSV 내에서 BEOL 시스템보다 50% 넘게 더 얇은 연속 탄탈륨 또는 티타늄 차단층과 구리 시드층을 증착할 수 있는 향상된 이온 밀도, 방향성, 에너지 조절 기능을 갖추고 있고 생산 비용을 크게 줄입니다. 더 얇은 필름과 더 높은 증착 속도 덕분에 Ventura 시스템의 처리량은 다른 BEOL PVD 시스템보다 두 배가 넘습니다.
고객은 이 시스템을 사용해 원하는 물질을 처리할 수 있습니다. 어플라이드 머티어리얼즈는 이러한 물질을 판매하지는 않지만 Ventura 챔버는 Endura 플랫폼에 통합해서 구리 시드층 공정과 함께 탄탈륨과 티타늄 차단층을 모두 처리할 수 있는 유연성을 갖추고 있습니다. 두 차단층 모두 높은 신뢰성을 입증했고 티타늄 차단층은 추가적으로 비용 이득을 제공합니다.
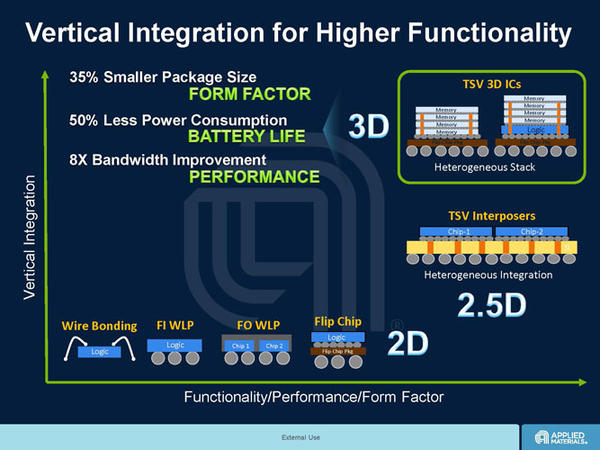


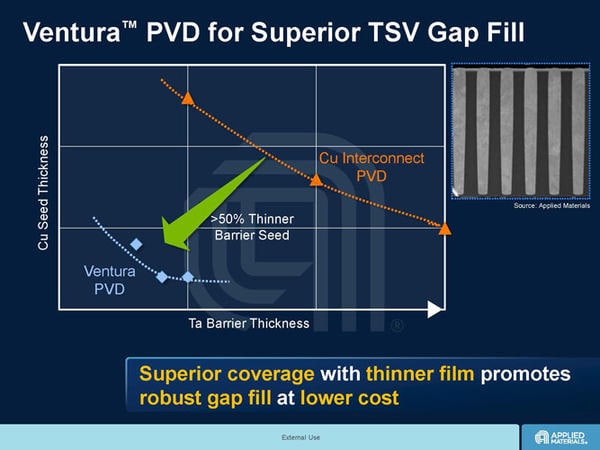



- 1 / 7
- 2 / 7
- 3 / 7
- 4 / 7
- 5 / 7
- 6 / 7
- 7 / 7
