Mirra CMP 200mm
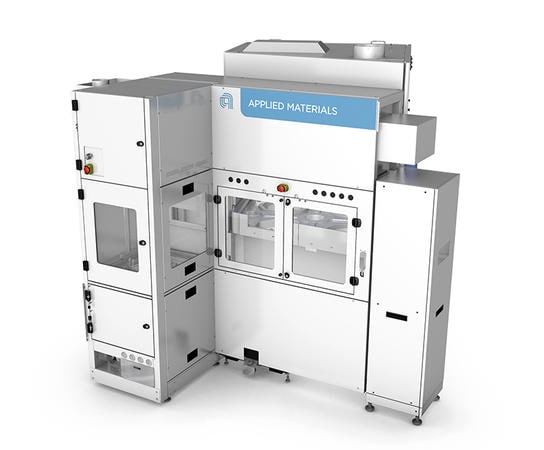
Applied Mirra CMP装置群は、多岐にわたる材料に対し、生産現場で実証済の高性能な平坦化ソリューションを150mmと200mm向けに提供します。高速平坦化プラテンとマルチゾーン研磨ヘッドは、優れた均一性と高効率を実現します。
シリコン、シャロートレンチアイソレーション(STI) 酸化物、ポリシリコン、タングステンに対応するApplied Mirraは、CMP工程後のMesa®クリーナーをインテグレートして、スラリーを効果的に除去し、残渣の形成を防ぎ、パーティクルやウォーターマーク形成を最小限に抑えることができます。
銅ダマシン、WLP、MEMSといった難易度の高いアプリケーション向けに、Applied Mirra装置では迅速かつ効果的なウォーターマークのない乾燥を実現するために、Marangoni™蒸気乾燥を備えたDesica®クリーナーを装備しています。
新しいApplied Mirra Durum™ は、Mirra CMP製品群を拡張しており、特にシリコンカーバイド(SiC)といった硬度の高い基板に特化しています。完全に自動化されたドライイン/ドライアウトの生産現場で実績のある装置で、クリーニングと乾燥、材料除去の計測、およびウェーハID読み取りを統合して量産において優れた表面品質を実現します。専用のハードウェアはより積極的なスラリーや化学薬品に最適化されています。レシピ制御による「ウェーハ反転」により、Si面とC面の自動研磨が可能です。この装置は、生産性を損なうことなく、150mmウェーハから200mmウェーハへと敏速に移行することが可能です。
全てのApplied Mirra装置は、オプションでエンドポイントモニタリング、インライン計測、先進のプロセス制御を提供し、これにより、あらゆる平坦化アプリケーションにおいて優れたウェーハ内およびウェーハ間のプロセス安定性と再現性を実現します。さらに、アプライド マテリアルズのProfilerやTitan Contour™ヘッド、マルチプラテン・コンフィギュレーションといった、高度な研磨技術にむけたオプションは、ウェーハ端部から3mm以内までのウェーハ表面全体にわたる除去レートをチューニングして、主要な均一性の基準達成を容易にします。
