半导体 (Semiconductor)
解决方案与软件
Endura CuBS Volta 钌
晶体管密度的不断提高要求布线越来越小,这对芯片制造的所有关键工艺都提出了更高的要求。应用材料公司的Endura™CuBS(铜屏障/种子)IMS™与 Volta™钌化学气相沉积技术(CVD)提供了一种解决方案,可在单一集成材料解决方案中降低功耗、提高性能并实现面积扩展。
在最先进的节点上用铜填充互连的 方法依赖于回流焊技术,利用退火将铜从晶圆表面流入布线沟槽和通孔。这种回流在很大程度上取决于铜必须在其上流动的内衬。传统方法是在大型设备中使用 CVD 钴膜来实现这一目的 然而。对于 3 纳米及更小的器件来说,这种薄膜太厚,会影响良率率和电阻。
通过钌钴(RuCo)二元衬里,应用材料公司将这一关键层的厚度缩减到 20Å 以下,并为导电铜线提供了更大的空间。 此外,这种新型薄膜的界面大大改善了回流机制,并在开发中最小的互连器件上实现了良率。
CuBS 铜布线工艺流程
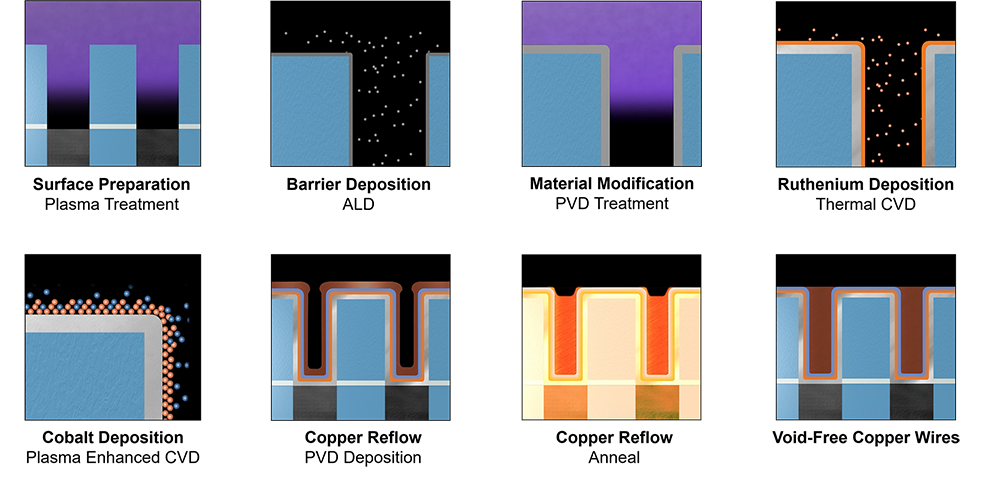

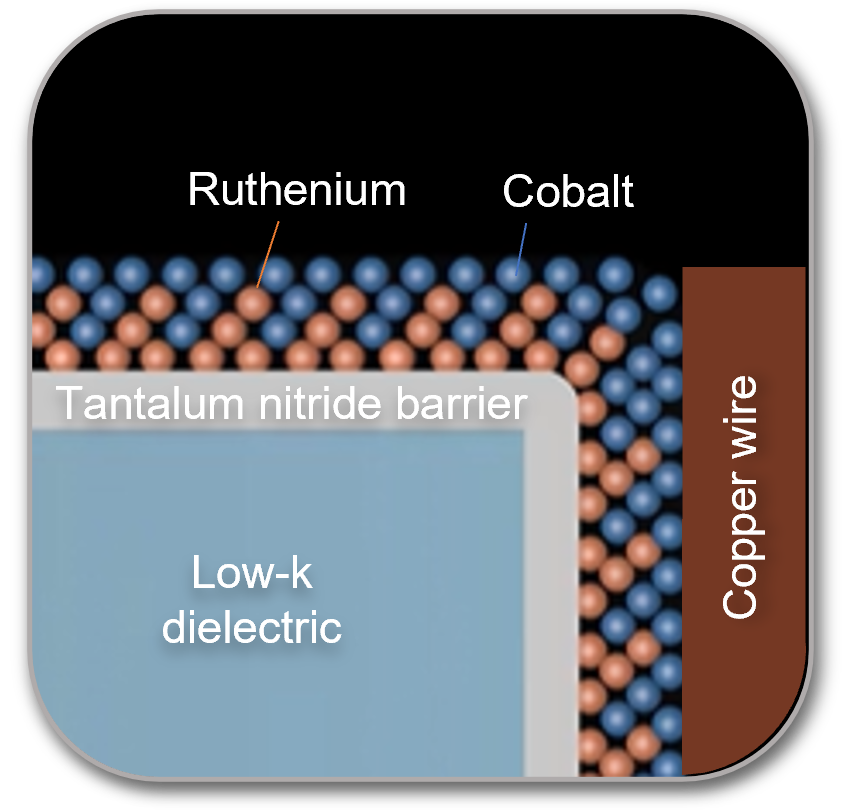



- 1 / 4
- 2 / 4
- 3 / 4
- 4 / 4
