製品・サービス
製品・サービス
半導体
市場と変化
ソリューションとソフトウェア
Endura CuBS Volta Ruthenium CVD
トランジスタの高密度化は、配線の微細化を要求し、チップ製造に関わるすべての重要な工程に負担をかけています。アプライド マテリアルズのEndura™ CuBS(Copper Barrier/Seed)IMS™ とVolta™ Ruthenium CVDは、単一の集積材料ソリューションで消費電力の削減、性能の向上、面積のスケーリングを可能にします。
最先端のノードで配線に銅を充填する方法はリフロー技術に依存しており、アニールを使ってウェーハ表面から配線トレンチやビアに銅を流します。このリフローは、銅が流れなければならないライナーに強く依存します。従来の方法では、大型デバイスではこの目的のためにCVDコバルト膜を使用していました。しかし、この膜は3nm以下のデバイスには厚すぎ、歩留まりと抵抗の両方を損ないます。
アプライド マテリアルズは、ルテニウムコバルト(RuCo)バイナリーライナーにより、この重要な層の厚さを20Å未満にし、導電性銅配線の体積を増やしました。さらに、この新しいフィルムによる界面は、リフローメカニズムを大幅に改善し、開発中の最小配線での歩留まりを達成します。
CuBS銅配線プロセスフロー
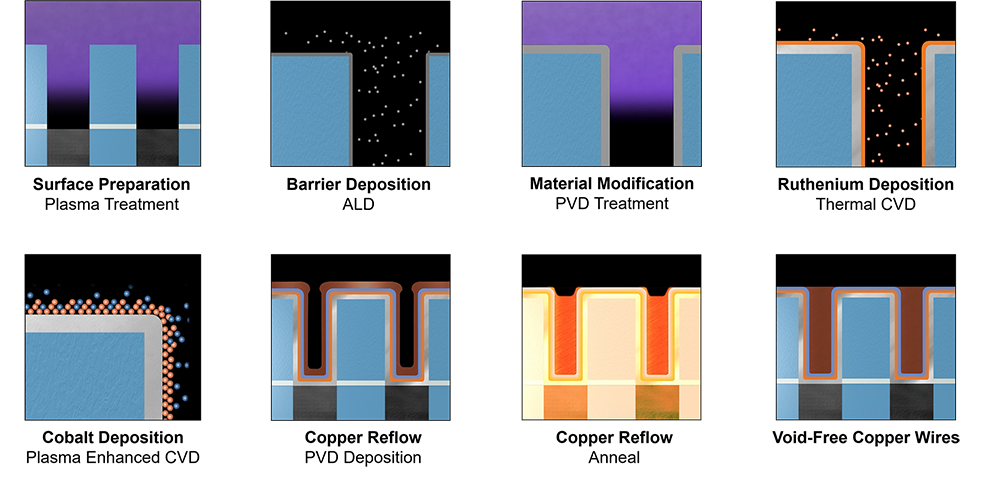
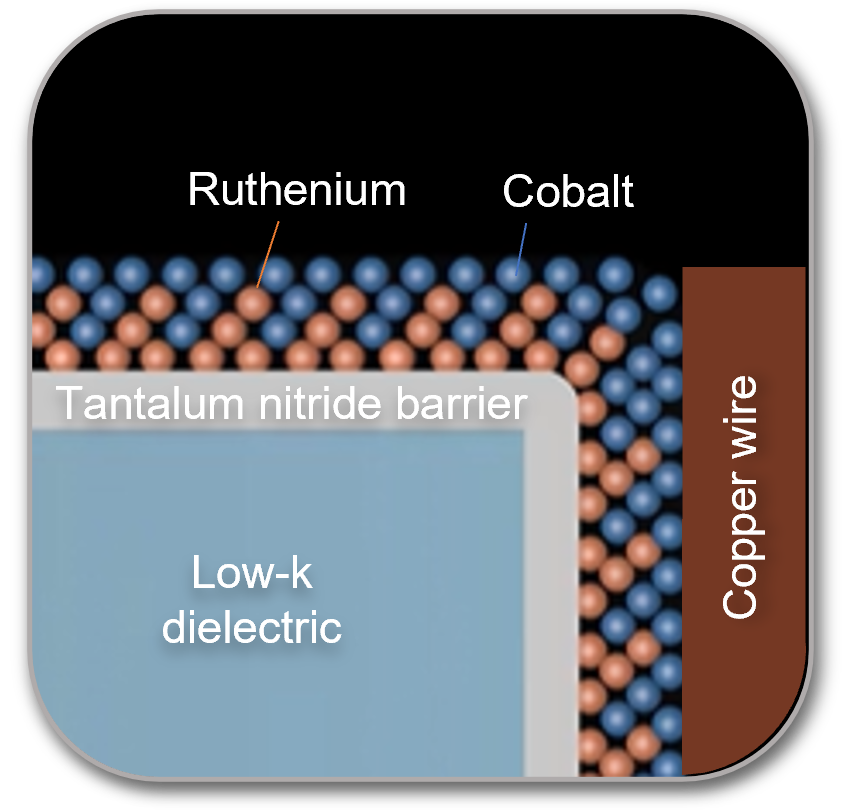



- 1 / 4
- 2 / 4
- 3 / 4
- 4 / 4
