製品・サービス
製品・サービス
コバルト製品群
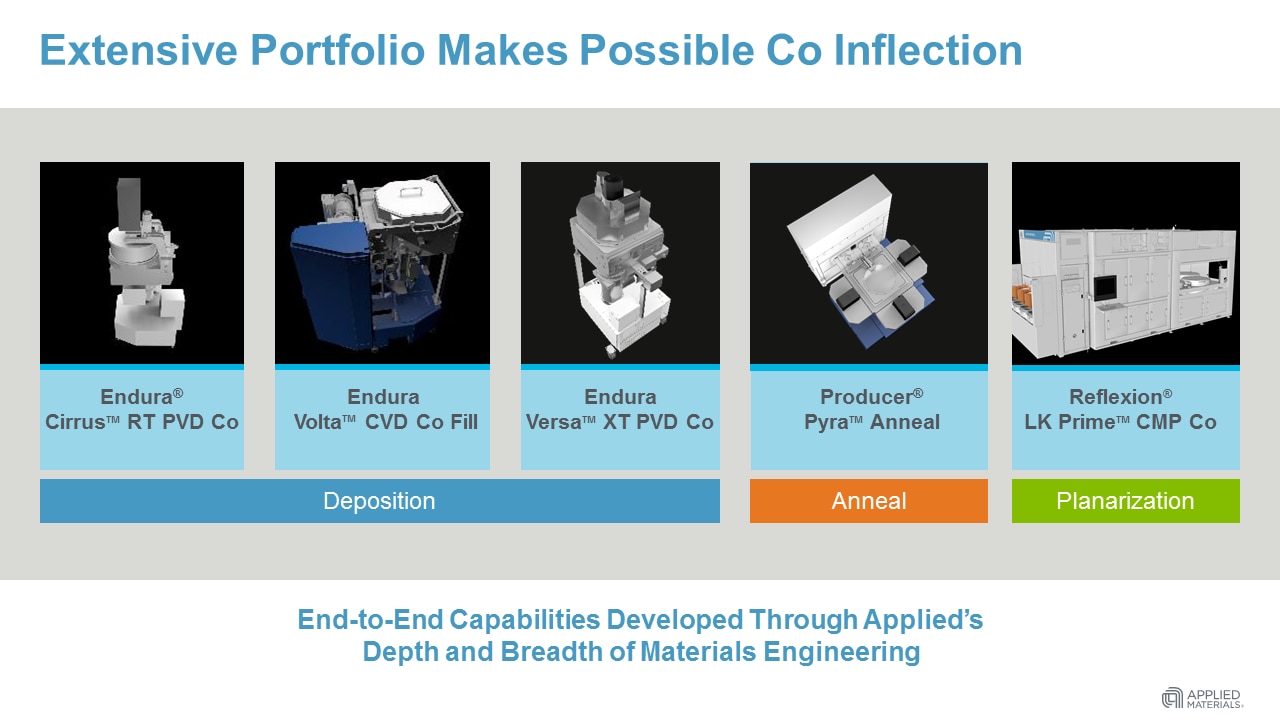
CDの微細化が継続して進むにつれて、デバイスの消費電力低減と性能向上は、コンタクトや内部配線の性能によってますます制限されます。7nmノード以降では、タングステン(W)の埋め込み抵抗増加が、消費電力の増加とチップ性能の低下をもたらします。1層目のCu配線も同様の課題に直面しており、Cuの体積が減少すると抵抗が増加し、チップの性能を低下させます。
Coは本質的にWに比べ低抵抗な材料であるのに加え、Coのコンタクトを形成するためのプロセスフローによって導電性金属の分量が増加し性能が向上します。それに伴ってばらつきが減少し、歩留まりが向上します。同様に、配線でもCoは優れた配線およびビア抵抗のスケーリングをもたらし、Cuに比べて少ないエレクトロマイグレーションを示し、より高い電流密度を実現します。
- Applied Endura Cirrus RT PVD Cobalt:最初のCo薄膜層を成膜し、これに後続のCVD Co層が密着します。
- Applied Endura Volta CVD Cobalt:PVD層に続いてCo埋め込み層を成膜します。この成膜プロセスで形成されたシームは、後続のアニール処理で除去されます。
- Applied Endura Versa XT PVD Cobalt:アニール処理後の厚い被覆層を成膜します。
- Applied Producer Pyra Anneal:ウェーハを加熱しCoのリフローを促し、バルクフィル中の継ぎ目を除去してグレインのサイズを大きく成長させ、Coの純度を高め、抵抗を減らします。この装置の詳細については、こちらをご覧ください。
- Applied Reflexion LK Prime CMP:Co研磨用に特別に最適化されたスラリーを使用することにより、前の工程で成膜された表面層を除去し、後続のプロセス工程用に平坦な表面を形成します。この装置の詳細については、こちらをご覧ください。


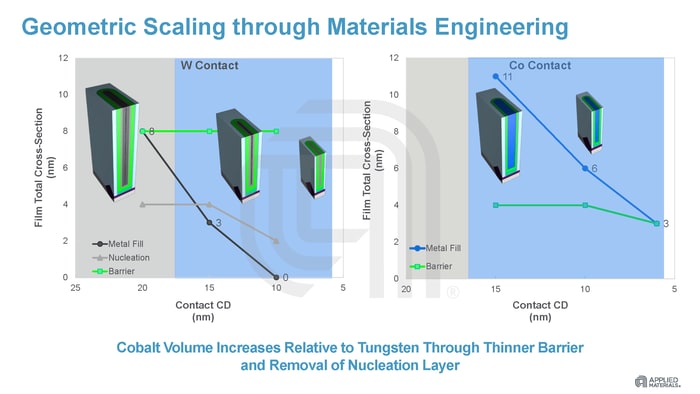

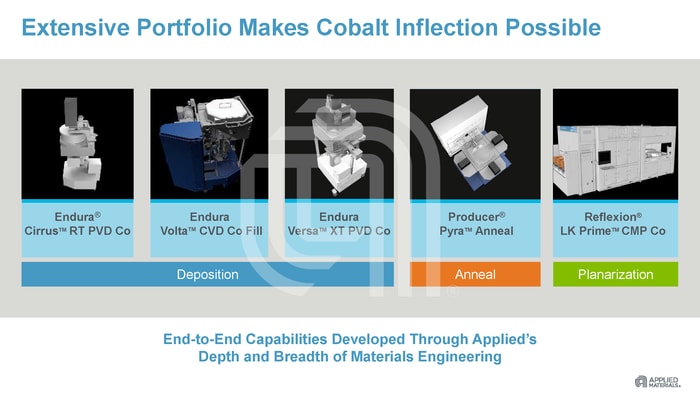
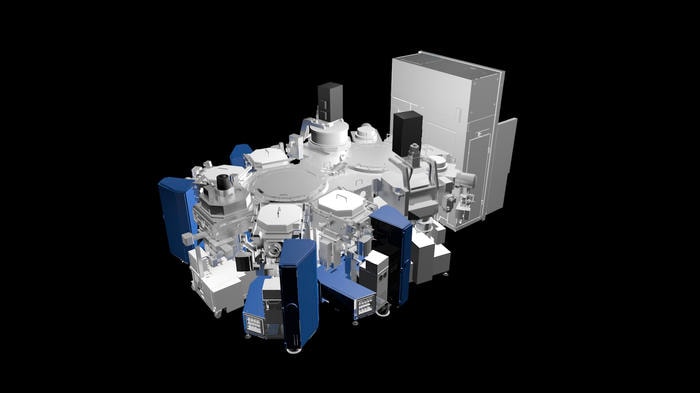
- 1 / 5
- 2 / 5
- 3 / 5
- 4 / 5
- 5 / 5
