半导体 (Semiconductor)
解决方案与软件
Centura™ Tetra™ Z 光掩膜刻蚀系统

Madhavi Chandrachood 探讨 Tetra™ 光掩膜刻蚀系统。
应用材料公司的 Centura Tetra Z 光掩膜刻蚀系统性能一流,可满足 10nm 及以下逻辑和存储器件的光掩膜刻蚀需求。新系统进一步提升了业内领先的 Tetra 平台的能力,提供了最佳的 CD 性能,以应对先进分辨率增强技术及将浸没式光刻延伸至四重图形曝光。
随着半导体行业不断扩大当前光刻技术的范围,Tetra Z系统是刻蚀10nm先进二元和掩模相移掩膜(PSM)所需的极端光学邻近效应修正(OPC)分辨率增强技术的重要推动因素。该系统通过控制可确保在所有特征尺寸和图形密度上实现均匀、几乎零缺陷的线性精确刻蚀,可在铬,氮氧化钼硅(MoSiON),硬掩模和石英(石英玻璃)上实现极高的图案转印保真度。
该系统极佳的 CD 性能配合高刻蚀选择比,使得其可以采用更薄的光刻胶薄膜,以在关键器件层实现更小掩膜 CD 的图形。系统能够控制 CD 偏差,拓宽了工艺灵活性,可满足客户的特定要求。独特的石英刻蚀深度控制,可确保精确的相位角度,使客户能够使用交替相移掩膜(PSM)和无铬相移光刻,以帮助微缩集成电路的尺寸。这些重要的性能提升,源自于以下诸方面的改进:工艺腔室的设计;等离子稳定性;离子、自由基、气流和压力的调控;工艺的实时监测和控制。
Tetra Z 系统可用于刻蚀多种不同类型的掩膜,最大程度降低了设备操作的复杂性,缩短了开发周期,以及减少对工艺库和专家级用户的依赖。近十年来,全球领先的光掩膜厂依靠 Tetra 刻蚀系统来刻蚀最先进的掩膜,且良率极佳。


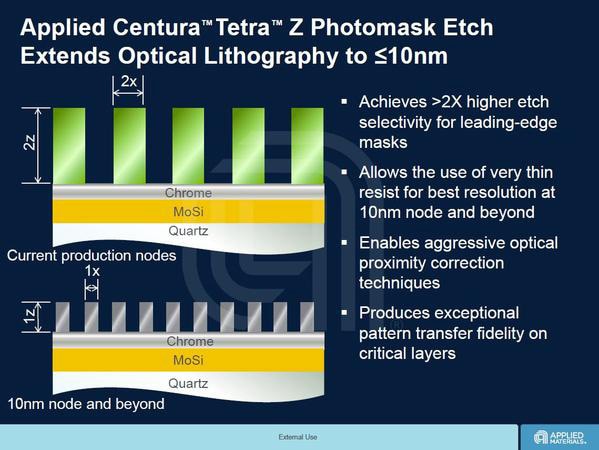
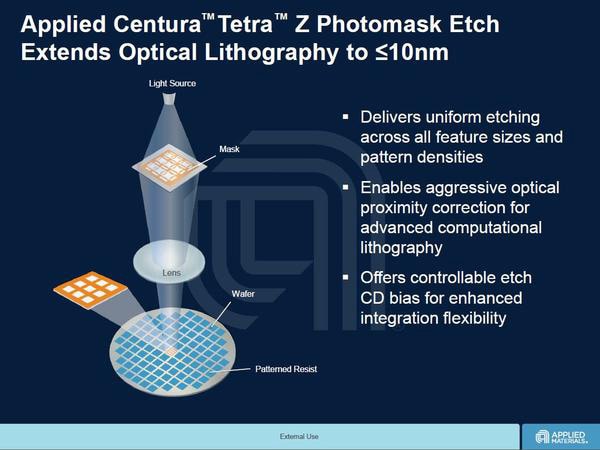
- 1 / 4
- 2 / 4
- 3 / 4
- 4 / 4
