Back to Menu
Centura® Tetra™ EUV Advanced Reticle Etch
극자외선(EUV) 포토마스크는 고에너지 단파장 광원을 사용하여 새로운 리소그래피 시스템을 통해 회로 패턴을 웨이퍼로 전달하는 데 사용됩니다. EUV 광원의 파장은 오늘날 사용하는 DUV 리소그래피보다 약 15배 가량 짧기 때문에 지속적인 형상 미세화가 가능합니다.
EUV 포토마스크는 웨이퍼에 회로 패턴을 투사하기 위해 193nm 파장의 빛을 선택적으로 전달하는 기존의 포토마스크와는 근본적으로 다릅니다. EUV 리소그래피가 사용하는 13.5nm 파장에서 모든 포토마스크 물질은 불투명하기 때문에 마스크에는 회로 패턴을 웨이퍼에 반사하기 위한 복잡한 다층 박막 거울이 들어 있습니다. 이러한 다층 EUV 마스크는 마스크 반사율을 유지하면서, 임계 치수(CD), 외형, 라인 에지 거칠기, 선택비, 결함률 제어 등 식각 공정과 관련한 특유의 당면 과제를 야기합니다.
Centura Tetra EUV 시스템은 어플라이드 머티어리얼즈가 마스크 식각 부문에서 오랫동안 지켜온 선도적 입지를 더욱 확장해 EUV 포토마스크에 사용되는 새로운 재료와 복잡한 필름 스택 식각을 위해 특별히 맞춰 설계되었습니다. 이 설계를 통해 이러한 반사 모드로 작동했을 때 높은 리소그래피 수율을 달성하기 위해 필요한 엄격한 패턴 정확성과 표면 마감 및 결함률 요건을 충족시킬 수 있습니다. 챔버 및 전력 공급 설계를 통해 특수한 공정 케미스트리 및 식각 기술을 보완하여 최고 수준의 CD 균일성과 세계적인 수준의 결함 제어 능력으로 사실상 손상 없는 식각 결과를 제공합니다.
Tetra EUV 시스템은 세계적인 마스크 선도업체들이 포토마스크 및 리소그래피 공정의 생산성과 수율을 극대화하기 위해 사용하는 어플라이드 머티어리얼즈의 종합적인 리소그래피 솔루션 포트폴리오의 한 부분을 이룹니다.



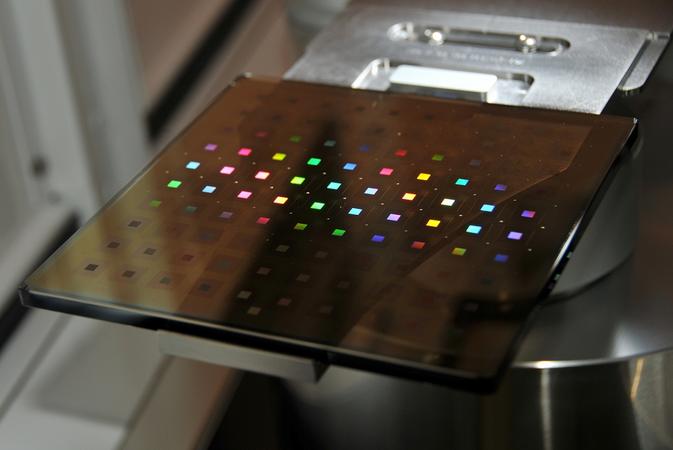
- 1 / 4
- 2 / 4
- 3 / 4
- 4 / 4
