Back to Menu
製品情報
Centura® Tetra™ EUV Advanced Reticle Etch
EUV(極端紫外線露光) フォトマスクでは、回路パターンをウェーハ上に転写する際に、高エネルギーの短波長光源を使用する新しいリソグラフィシステムを用います。EUV光源の波長は現在の深紫外線リソグラフィの波長の約15分の1となり、この波長によりさらなる微細化を進めることができます。
EUVフォトマスクは、波長193nmの光を選択的に透過させてウェーハに回路パターンを投影する従来のフォトマスクとは全く異なります。EUVリソグラフィで用いる波長13.5nmの光(極端紫外線)は、どのフォトマスク材料に対しても透過性を持たないため、代わりに複雑に多層化されたミラーをフォトマスクに組み込み、反射光をウェーハ上に導いて回路パターンを形成します。このような多層EUVフォトマスクには、フォトマスクの反射率を維持しながら寸法精度(CD)、プロファイル、ラインエッジラフネス、選択性、欠陥制御という、エッチングにおける特有の課題があります。
Centura Tetra EUVシステムは、アプライド マテリアルズの長年にわたるマスクエッチングにおけるリーダーシップをさらに拡大する製品です。EUVフォトマスクで使用される新素材と複雑なフィルムスタックのエッチングに特に照準を合わせて設計されており、厳密なパターン精度、表面仕上げ、欠陥仕様の厳しい要件を満たし、反射モードで操作されるリソグラフィーにおいて高い歩留まりを実現します。特化したプロセスガスとエッチング技術を補完するチャンバおよび送電設計により、実質的にダメージフリーのエッチングと、最高クラスのCD均一性および世界トップクラスの欠陥制御を提供します。
Tetra EUVシステムは、世界中の先進マスクメーカーがフォトマスクとリソグラフィーの製造における生産性の最適化と歩留まりにおいて信頼を寄せている、アプライド マテリアルズの包括的なリソグラフィー対応ソリューション製品群の一部です。



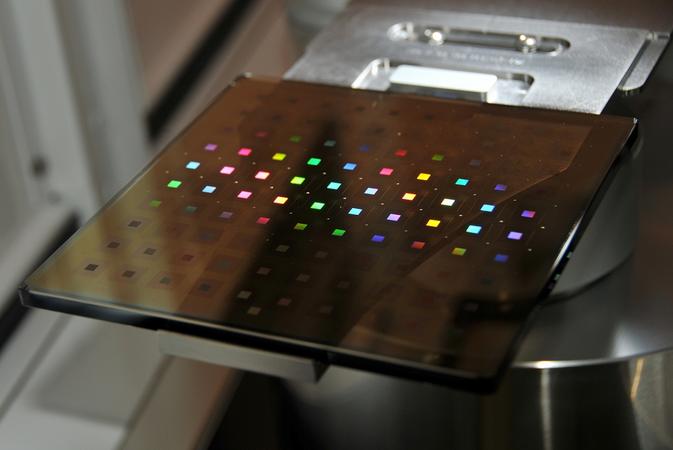
- 1 / 4
- 2 / 4
- 3 / 4
- 4 / 4
