半导体 (Semiconductor)
Centura® Tetra™ EUV 先进光掩模刻蚀系统
极紫外光 (EUV) 光掩膜用于新式光刻系统中,通过高能、短波长光源,将电路图形转印到晶圆上。EUV 光源的波长约为目前深紫外光刻所用光源波长的十五分之一,从而能够进一步微缩特征尺寸。
EUV 光掩膜与传统的光掩膜截然不同,后者是有选择性地透射 193nm 波长的光线,将电路图形投射到晶圆上。EUV 光刻采用 13.5nm 波长的光源,所有光掩膜材料都不透明,由掩膜中的复杂多层反射镜将电路图形反射到晶圆上。这种多层 EUV 光掩膜在保持反射率的同时,也在关键尺寸 (CD)、形貌、线条边缘粗糙度、选择比和缺陷控制方面为刻蚀工艺带来独特的挑战。
Centura Tetra EUV 系统针对 EUV 光掩膜所需新材料及复杂多层结构的刻蚀做了特别的设计,以满足图形精度、表面光洁度和缺陷方面的严苛规格,在反射模式下达成高的光刻良率,延续了应用材料在掩膜刻蚀领域的长期领先地位。优化的腔体和功率输出设计配合专门的工艺气体和刻蚀技术,提供了几乎无损伤的刻蚀,业界最佳的 CD 均匀性和国际一流的缺陷控制水平。
Tetra EUV 系统是应用材料公司全面的光刻系列解决方案之一,全球众多领先的光掩膜厂依靠此解决方案来优化光掩膜和光刻工艺生产的产能和良率。



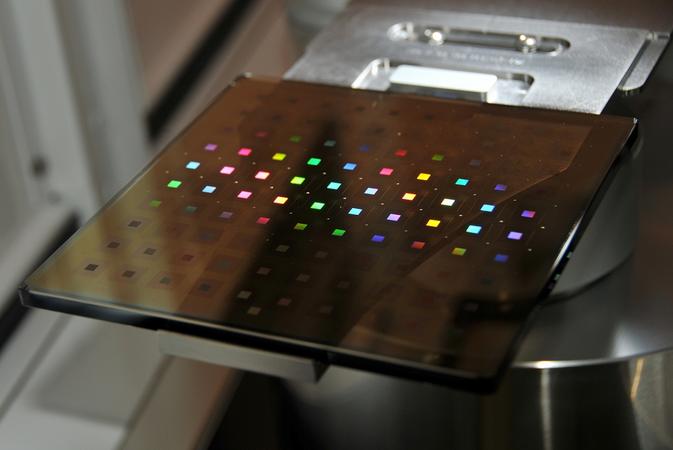
- 1 / 4
- 2 / 4
- 3 / 4
- 4 / 4
