半導體 (Semiconductor)
Centura® Tetra™ EUV 先進光罩蝕刻系統
極紫外線 (EUV) 光罩是以新式微影系統,透過高能量、短波長的光源,將電路圖案轉印到晶圓。EUV 光源波長比目前深紫外線微影製程的光源波長短少約 15 倍,因此能持續將線寬尺寸縮小。
EUV 光罩與傳統的光罩截然不同,後者是有選擇性地傳輸 193nm 波長的光線,將電路圖案投射到晶圓上。當採用 13.5nm 波長的極紫外光微影技術時,所有的光罩材料都是不透光的,因此具複合多層薄膜的光罩,功用如同反射鏡,可將電路圖案反射到晶圓上。這種多層膜 EUV 光罩在臨界線寬 (CD)、輪廓、刻線邊緣粗糙度、選擇性和缺陷控制方面造成獨特的蝕刻挑戰,且仍需維持光罩的反射率。
Centura Tetra EUV 系統藉由專門的設計,可針對 EUV 光罩製程中採用的新材料及複合薄膜堆疊進行蝕刻,能在以這種反射模式操作時,符合嚴格的圖案精度、表面平滑度和缺陷等必要規格,以達到高的微影良率,也因此延續了應用材料公司在光罩蝕刻領域的長期領先地位。該系統的反應室及功率輸出的設計,可與專門的製程化學反應及蝕刻技術配合使用,提供幾乎完好無損的蝕刻效果,並帶來極佳的臨界線寬均勻性和世界一流的缺陷控制水平。
Tetra EUV 系統是應用材料公司具備微影功能的全系列解決方案之一部份,全球眾多領先的光罩製造廠都需依靠此解決方案,使其光罩和微影產品營運達到最佳產能和良率。



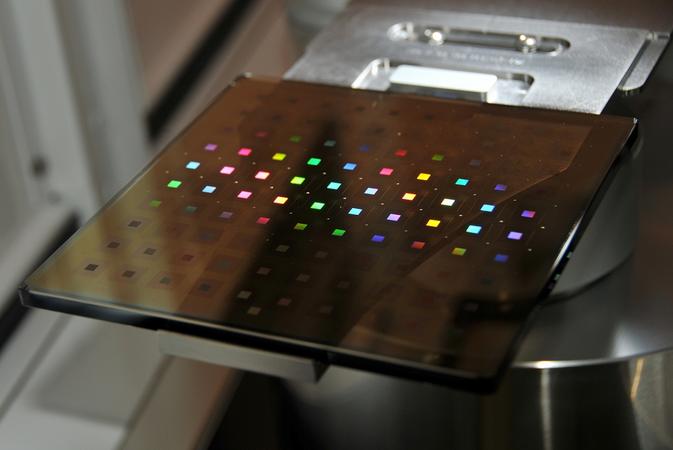
- 1 / 4
- 2 / 4
- 3 / 4
- 4 / 4
