半导体 (Semiconductor)
技术
-
ALD
-
CMP
-
CVD(化学气相沉积)
-
ECD
-
外延生长
-
刻蚀
-
离子注入
-
测量与检测
-
Pattern Shaping
-
光掩膜
-
PVD(物理气相沉积)
-
快速热处理(RTP)
-
模拟
-
化合物半导体
-
微机电系统(MEMS)
-
功率
晶圆制造厂环境解决方案
Centura™ Silvia™ 刻蚀
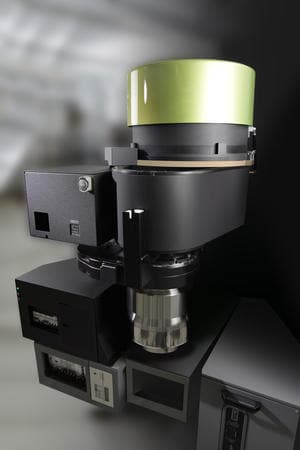
TSV 为产品设计师在高效空间利用方面提供了新的设计自由度,它不仅使各节点的电路元件能够集成,而且增强了功能与性能,使之优于引线接合和倒装芯片 3D 方案。
器件制造商正在使用各种方案来集成芯片,以便最大限度地提高功能体积比。TSV 技术通过创建垂直通道来实现 3D 互连,这些通道作为集成电路组件,起到连接堆叠芯片或晶圆的作用。在芯片或晶圆之间建立垂直连接,需要深硅刻蚀工艺,
应用材料公司的 Centura Silvia 刻蚀 就是针对这种充满挑战的工艺而专门设计的系统。传统方法需要在形貌控制与高刻蚀率之间做出取舍,而只有应用材料公司的 TSV 刻蚀系统能够克服这一弊端。该系统的高密度等离子源可在所有晶圆级封装应用中实现最高的硅和氧化硅刻蚀率。
应用材料公司是深硅刻蚀和 TSV 生产技术领域的领先创新者和市场领导者,借助公司在这些领域的长期经验,Silvia 可以优化 3D 互连刻蚀应用所需的刻蚀性能。由于刻蚀工艺约占 TSV 制造工序的 15%,所以 Silvia 的高生产能力大幅削减了经营成本,而无耗材的工艺套件又带来了 CoC 优势,这些因素对缩减客户采用 TSV 技术的总成本至关重要。
