Endura® Cirrus™ HTX PVD
通过革新用于氮化钛 (TiN) 薄膜的物理气相沉积 (PVD) 技术,Endura Cirrus HTX TiN 解决了下一代设备的硬掩膜可扩展性挑战。 随着芯片特征尺寸的进一步缩小,硬掩膜创新对于更复杂微小互连结构的精确图形化至关重要。 借助在 PVD 领域多年的专门技术,新系统可生产能够在 10nm 以下的节点中确保图案保真度的突破性硬掩膜。
随着芯片设计的发展,芯片的特征尺寸逐渐变小、深宽比变得更高、封装越来越密集,以便生产先进的集成电路。结果,在创建电路(或互联线)时,用于定义刻蚀的和金属化的图形的材料对保持这些图形的完整性极其重要。轻微的缺陷可能造成无法适当地金属化器件,使其不可靠或无功能。
在互连线制造工艺中,氮化钛 (TiN) 一直是低 K 介电质图形化的标准硬掩膜材料。然而,在先进节点,为降低器件电容,将介电质逐渐制作得更加多孔,使其变得更脆弱,并且在叠加的 TiN 掩膜的压缩应力影响下,容易在刻蚀后变形(线路弯曲和图形坍塌)。尽管消除这一自然压缩应力会降低薄膜密度,但这对耐受刻蚀工艺是必须的。
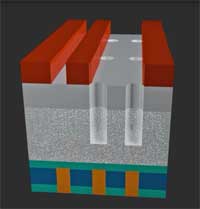
传统 TiN 的压缩应力会导致在密集复杂的互连线中发生线宽变异和图样崩溃。
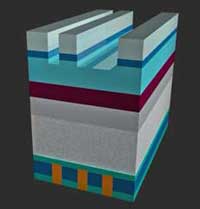
可拉伸的高密度 Cirrus™ TiN 可实现紧密的线宽控制和通孔堆叠对准,以保持密集、复杂的互连线的图形完整性。
在一项重大突破中,Endura Cirrus HTX PVD 系统采用了频率极高的 RF 源,以产生便于修改薄膜的结晶定向的高度电离化等离子体,从而解决了应力和密度之间的棘手权衡。最终形成的 TiN 达到了抗张应力性与高密度的理想结合,从而带来极佳的刻蚀选择比、出色的 CD 线宽控制和通孔堆叠对准,以及密集复杂图形的高保真度。出色的薄膜厚度均匀性与低缺陷率使新系统能够减少变异性和产生非常精确的图形。

Cirrus™ TiN 中的晶体生长机制可以形成无孔洞薄膜和更平滑的顶面。

Cirrus™ TiN 中的晶体生长机制可以形成无孔洞薄膜和更平滑的顶面。


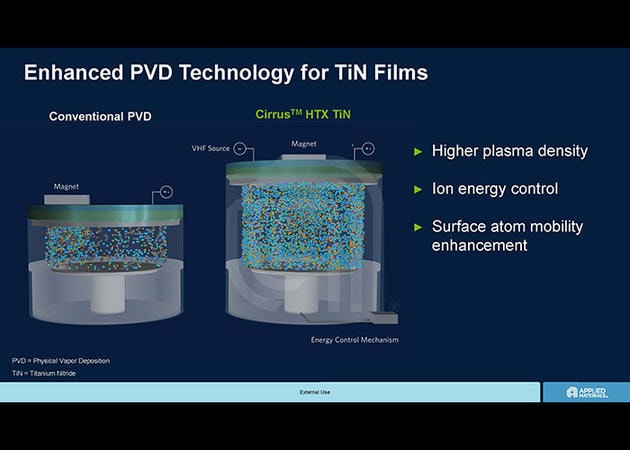
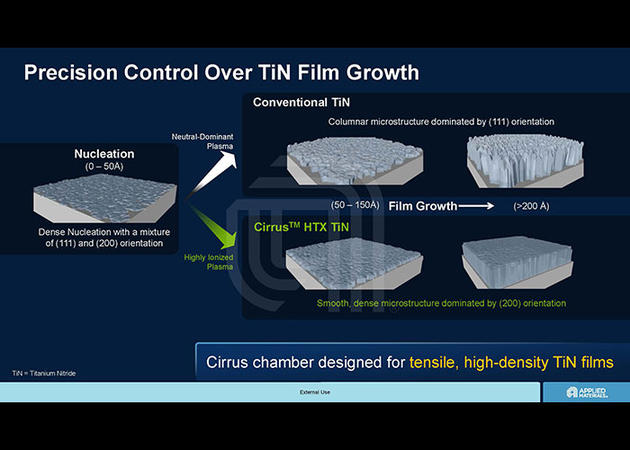
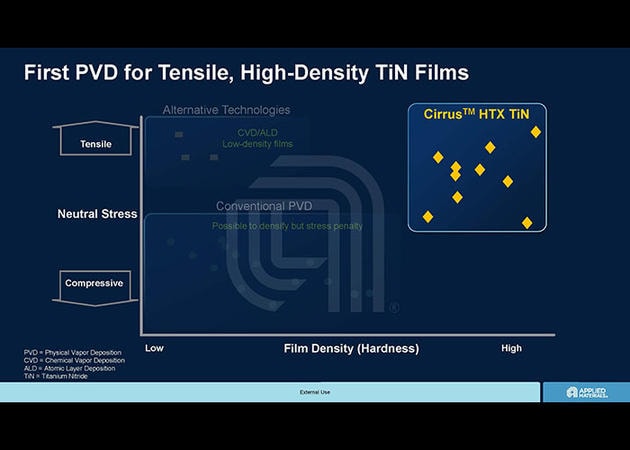
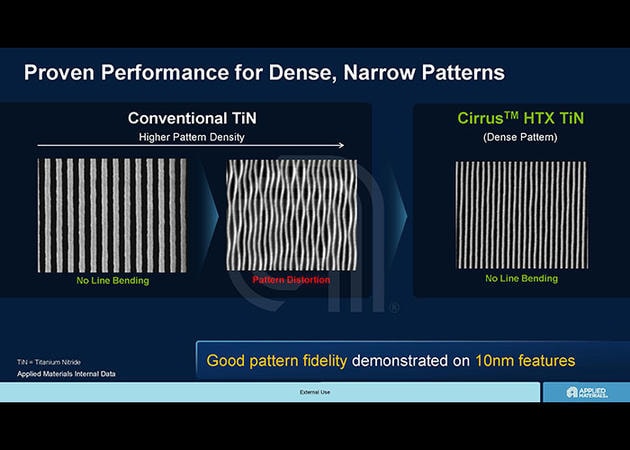
- 1 / 6
- 2 / 6
- 3 / 6
- 4 / 6
- 5 / 6
- 6 / 6
