Centura® DXZ CVD
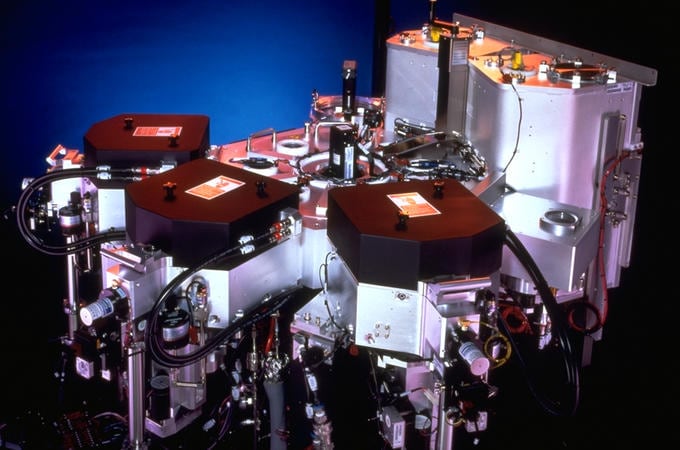
先进MEMS ,功率器件和封装中的应用驱动了对先进的150mm和200mm CVD技术的需求。为满足这些技术的制造要求,需要超厚氧化物(≥20µm),低温(180°C-350°C),保形的、低湿刻蚀速率的薄膜和折射率可调的掺杂薄膜。这些薄膜加入了Centura DXZ CVD系统上可用的广泛工艺组合,从TEOS ,基于硅烷的氧化物和氮化物到低k介电质,应变工程和可光刻的薄膜。该系统还产生各种掺杂(膦,硼和氟)和未掺杂的间隙填充溶液。这些过程处理诸如STI , PMD , ILD和IMD之类的应用程序。
碳化硅(SiC)是新兴的用于高速应用的材料。然而,其透明性使得晶圆处理变得特别严苛。DXZ CVD系统配备了增强的功能,能可靠而细致地处理碳化硅(SiC)晶圆,包括从Loadlock的晶圆映射,到清晰的晶圆定向,再到晶圆放置。
Centura DXZ系统设计显著优化了成本(例如零耗材的处理套件)、吞吐量、易维护性和可靠性。该系统采用单晶圆、多腔室架构,可提供高达80wph的正硅酸乙酯(TEOS)和碳化硅(SiC)吞吐量(3,000ÅPE 正硅酸乙酯和等离子硅烷)和高达35wph的非掺杂二氧化硅晶体(USG)吞吐量(2000ÅSACVD USG)。对称的设计和较小的腔室容积可提高沉积和清洁化学品的有效气体利用率,从而降低总体拥有成本。
Centura DxZ CVD 腔室采用了非消耗型电阻加热器和陶瓷部件,可显著改善成本、产能、易维护性和可靠性。DxZ 工艺套件也由零消耗部件组成。借助单晶圆多腔室架构,Centura DxZ 可提供高达 100WPH(3,000Å PE TEOS 和硅烷等离子体)和 55wph (3000Å SACVD USG) 的产能。对称式设计和小腔室容量,对于沉积和清洁化学物可实现高效的气体利用率,这有助于降低总体拥有成本。
