Centura® DXZ CVD
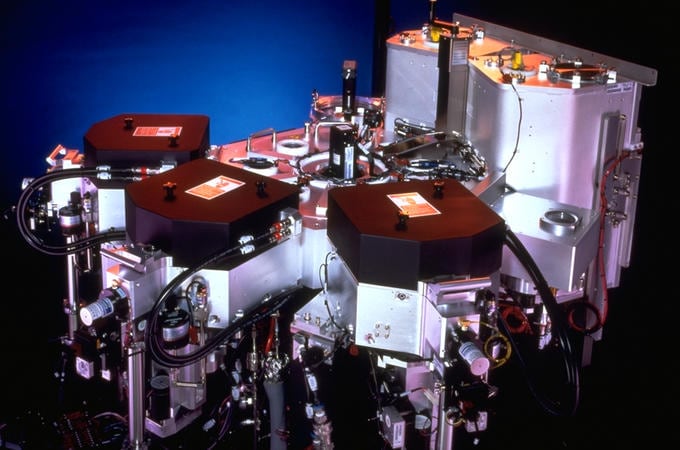
先進MEMS 、功率元件和封裝中的應用驅動了對先進的150mm和200mm CVD技術的需求。為了滿足這些技術的製造要求,需要超厚氧化物(≥20µm)、低溫(180°C-350°C)、高均勻度、低濕蝕刻速率的薄膜和可調折射率的摻雜薄膜。Centura DxZ CVD 系統可提供這些薄膜所涉及的廣泛製程,從TEOS 、矽烷為基底的氧化物和氮化物到低k介電質、應變工程和可微影的薄膜。該系統也生產各種摻雜(膦,硼和氟)和未摻雜的間隙填充溶液。這些製程處理諸如STI , PMD , ILD和IMD之類的應用。
碳化矽(SiC)是用於高速應用的新興材料之一。然而,其透明性使得晶片處理特別苛刻。DXZ CVD系統配備了強化功能,可以可靠而謹慎地處理碳化矽( SiC)晶圓,從承載器晶圓定位到明確的晶圓定向再到晶圓擺放。
Centura DXZ系統設計顯著改善了成本(例如零耗材的製程套件)、產量、易維護性和可靠性。該系統採用單晶圓、多反應室架構,可提供高達80wph的原矽酸四乙酯 (TEOS) 和碳化矽產量 (3,000Å PE TEOS和電漿矽烷) 和高達35wph的USG產量 (2000Å SACVD USG)。對稱的設計和較小的反應室體積可提高沉積和清潔化學品的有效氣體利用率,從而降低總體擁有成本。
Centura DxZ CVD 反應室採用了非消耗型電阻加熱器和陶瓷部件,可顯著改善成本、產能、易維護性和可靠性。DxZ 製程套件也由零消耗部件組成。借助單晶圓多反應室架構,Centura DxZ 可提供高達 100WPH(3,000Å PE TEOS 和矽烷電漿)和 55wph (3000Å SACVD USG) 的產能。對稱式設計和小反應室容量,對於沉積和清潔化學可實現高效的氣體利用率,這有助於降低總體擁有成本。
